GaAs基片高温加热清洗过程中残气脱附的研究
为了优化GaAs 基片的加热清洗工艺, 获得原子级清洁表面, 用四极质谱仪研究了GaAs 基片高温加热清洗过程中常见气体及Ga、As 元素的脱附规律。研究结果表明: 常见气体(H2、H2O、N2、CO、CO2、Ar、CxHyOz ) 在100℃左右开始大量脱附;Ga、As元素主要以单质和氧化物的形态脱附, 其脱附的温度存在两个峰值, 分别是300℃和600℃; 研究还发现真空环境中某些常见气体的含量会影响到Ga、As元素的脱附形式, 当H2含量较高时, 一部分As会以AsH3的形态脱附, 当H2含量较低时, As基本以单质的形态脱附。经过多次实验及对实验结果的分析, 最终确定了高温加热清洗的升温曲线及加热清洗的最高温度,获得了较为理想的原子级清洁表面。
GaAs 负电子亲和势光电阴极是一种高性能的光电阴极, 获得负电子亲和势的方法是用Cs、O交替激活阴极表面。然而在激活之前, 阴极表面必须是一个原子级清洁表面, 否则阴极表面吸附的杂质会严重影响激活后光电阴极的性能。
经过化学清洗后的光电阴极表面不能称为原子级清洁表面, 此时的表面还吸附有大量的H2、H2O、N2、CO、CO2、Ar、CxHyOz 等气体分子, 而且化学清洗并不能彻底除去表面的氧化物。本文采用了化学清洗后再通过高温加热清洗的方法来获得原子级清洁表面, 研究了GaAs 基片高温清洗时表面吸附物的脱附温度及脱附量。
1、清洗步骤
将化学清洗后的GaAs基片放入超高真空系统的预抽室, 待真空度降到10-6 Pa 再将基片转到激活室的加热台。此时激活室的真空度会有所下降,待真空度恢复到10-8 Pa, 打开四极质谱仪, 待系统真空度稳定, 就可以进行加热清洗操作。目前, 采用的加热清洗步骤如图1所示, 0~ 5min 温度从室温变化到100℃ , 5~ 220 min 温度从100℃变化到650℃ , 220~ 250 min 温度保持在650℃ , 250~ 300min 温度从650℃降到200℃ , 最后自然冷却到室温。
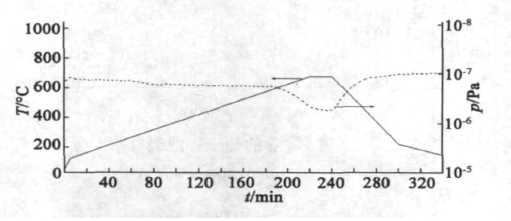
图1 加热温度设定及真空度变化曲线
在高温加热清洗过程中, 采用真空计记录激活室的真空度变化曲线, 四极质谱仪记录各气体组分的分压强。
2、数据分析
2.1、 常见气体的分析
2.1.1、 常见气体的变化规律
由于吸附于GaAs 基片表面的常见气体属于物理吸附, 因此在GaAs基片加热的开始阶段, 吸附的常见气体就会大量脱附。这些气体主要有H2、H2O、N2、CO、CO2、Ar、CxHyOz。它们的变化规律基本相同, 可以把加热前后的整个过程可以分为五个阶段,以H2O为例, 如图2 所示。
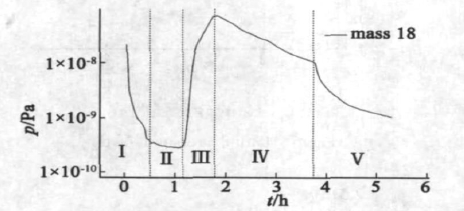
图2 H2O的分压强曲线
第一个阶段是开始的0.5 h。此时加热尚未进行, 质谱仪打开后, 质谱仪灯丝加热产生高温及电子发射, 吸附在质谱仪腔管及灯丝上的气体开始脱附,导致气体分压强突然增大。此时气体的分压强并不能代表超高真空系统腔室内的分压强。
第二个阶段是曲线较为平缓的部分。质谱仪预热脱附掉的气体, 在大约0.5 h 内被离子泵捕获, 气体分压强维持在比较稳定的状态。此时的气体分强可以代表加热前超高真空系统的本底分压强, 可以开始加热了。
第三个阶段是刚开始加热的阶段。此阶段是加热的前期, 温度上升比较快, 吸附于基片的气体大量脱附导致气体分压强直线上升。不同气体分压强到达最大值的时间略有不同, 这主要与各气体的含量与脱附能有关, 含量高、脱附能大的需要的脱附时间就长。
第四个阶段从气体分压强到达最大值开始至停止加热结束。此阶段加热仍在进行, 升温速度较慢,气体的脱附进入动态平衡。温度每升高一度, 平衡破坏, 就会有少量气体脱附, 离子泵将脱附气体捕获, 建立新的平衡。此时温度上升的斜率决定着气体分压强下降的斜率, 直到加热停止。此阶段过后, 吸附于基片上的常见气体基本脱附到理想的水平。
第五个阶段从停止加热开始至基片冷却到室温结束。从图2可以看出, 降温过程中, 气体分压强按指数规律减小。这说明离子泵的捕缚能力及激活室器壁的吸附能力是按指数规律变化的。
2.1.2、常见气体含量定量分析
几种常见气体的分压强如图3所示。
如图3所示, 就最大值来看, 含量最多的气体是荷质比为28 的物质, 荷质比为28 的物质有N2、CO、C2H4。先来分析N2 的含量, 荷质比为14的N 含量为1.2× 10-9 Pa, 一般真空系统中N2 在荷质比14处的丰度约为6%, 可以算出N2 的含量约为2×10-8 Pa, 而荷质比为28 的混合物含量为1.1×10-7 Pa, 可见N2 的含量只占不到1/5。同理来分析C2H4 的含量, 由于荷质比为27的C2H3 含量为1.1×10-8 Pa, 可以算出C2H4 的含量也很少。这样可以确定荷质比是28 的气体主要是CO, 其次是N2、C2H4。
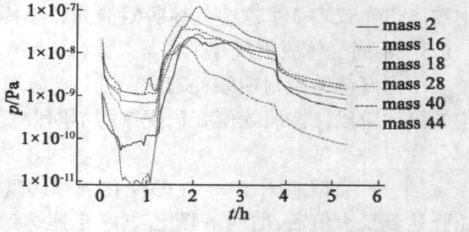
图3 常见气体的分压强曲线
荷质比位居第二的气体是荷质比为18的H2O,加上荷质比为17的OH, H2O 的含量将超过CO, 成为超高真空系统中含量最多的气体, 其分压强最大值可达1.05×10-7 Pa。荷质比位居第三的气体是荷质比为16 的物质,荷质比为16 的物质有CH4、O、NH2, 通过图4 可以确定出荷质比为16 的物质主要是CH4。这是因为图中荷质比为15 的是CH4 的副峰CH3, 而且荷质比为16 的曲线跟荷质比为15 的曲线极为相似, 从而排除了O、NH2 的可能性。
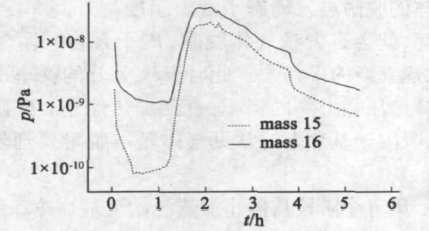
图4 相似曲线
超高真空系统中含量比较多的气体还有H2和CO2,他们的含量和CH4 相当, 分别为2.5×10-8, 2.7×10-8 Pa。另外还有一种稀有气体Ar(1.5× 10-8 Pa) 以及少量的CxHyOz。作图3 的微分曲线, 就可得到各气体脱附的速率曲线, 假定速率曲线的峰值为气体大量脱附的表征, 据此可以得到各气体脱附的难易程度, 根据峰值出现的先后顺序, 得出的脱附先后顺序为Ar,H2O,H2, CO, CO2, 碳杂质, 由于常见气体的脱附难易程度跟气体的脱附能及含量有关, 因此各常见气体的脱附顺序也大致表征了这些气体脱附能的大小关系。