正交电磁场离子源及其在PVD 法制备硬质涂层中的应用
离子源是离子束产生的关键部件,正交电磁场离子源是以霍尔电流为理论基础的一类低能离子源。本文综述了考夫曼离子源、霍尔离子源以及阳极层线性离子源的发展历程及其在结构与功能方面的区别,分析了各种离子源在PVD 法制备不同体系超硬涂层中的应用及对涂层结构、性能的影响,概述了国内外离子源的现状,并指出了国内离子源存在的问题。
1、前言
物理气相沉积(Physical Vapour Deposition,PVD)法作为传统的硬质涂层制备方法,具有低温、高速两大突出特点,所形成的涂层致密,具有较小的摩擦系数,一直在高质量硬质涂层制备方法中占据重要位置。但PVD 法沉积粒子能量普遍不高,在制备涂层时难以越过高温高压相形成能垒,在获取特定相结构时有一定的局限性。在基片上施加负偏压可以加强离子对基片的轰击,增强沉积过程的能量,但对正离子的吸引过程不具备选择性,离子入射的角度也不可控,独立性较差。
离子束辅助沉积(Ion Beam Assisted Deposition,IBAD)是一种将离子束及涂层沉积两者融为一体的材料表面改性和优化技术,最初应用于半导体器件领域,近年来,其应用范围不断拓宽,辅助制备硬质涂层方面的报导也屡见不鲜。用于表面改性的离子束按能量大小,一般以10 KeV 为界,分为高能和低能两类。高能离子束一般应用于离子注入等领域,需要成本较高的粒子加速器,同时高能离子对涂层的反溅射作用明显,容易使已沉积的涂层再次离开基片,而大大降低沉积速率;低能离子束主要用于辅助沉积,较易获得,与PVD 法结合,不但可以增强沉积过程的能量,也可实现对入射离子种类、束流强度及入射方向的单独控制,可独立摸索沉积参数,优化工艺参数后可明显改善涂层致密度、晶粒大小、晶粒取向、表面形貌等性能,达到提高膜- 基结合力的目的。特别是在对沉积温度有特殊要求的条件下,离子束辅助沉积可以在保持基片低温的前提下,提高涂层在沉积过程中的能量。
离子源是产生离子束的核心部件,其中正交电磁场离子源(Orthogonal Electromagnetic Field type ion source)是通过电磁场束缚电子运动,使气体电离为正离子后,在电场或电磁场作用下加速形成离子束。相较于其他形式离子源,如电子回旋共振(Electron Cyclotron Resonance,ECR)、电容耦合离子源(Capacitively Coupled Plasma,CCP),其成本低廉,更适合工业应用。本文将介绍几种不同类型的正交电磁场离子源,并结合其在不同体系硬质涂层沉积过程中的应用,综述离子源的结构、工作原理;分析其产生的离子束对硬质涂层成分、结构、性能的影响。
2、正交电磁场离子源工作原理
2.1、考夫曼(Kaufman)离子源
八十年代美国宇航局的Kaufman 教授设计了此类离子源,至今仍是应用最广泛的一种离子源。图1、图2 所示为两种不同磁场设置的考夫曼离子源,多极考夫曼离子源可形成更均匀的等离子体区,引出的离子束均一度也会更高。其基本原理与轴向考夫曼离子源相近:钨丝热阴极提供的原初电子被放电室内的正交电磁场约束,电子与气体碰撞频率升高,放电室内等离子体密度增加。正离子通过屏栅、加速栅、抑制栅构成的三栅吸出系统形成宽束离子流,其中屏栅的开孔密度与孔径决定了离子源放电室内外的气压差,气体流动的通导比。加速栅接负高压用于正离子的加速吸出,抑制栅接地用于防止正离子回流。
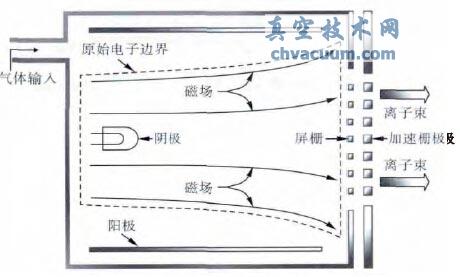
图1 轴向考夫曼离子源简图
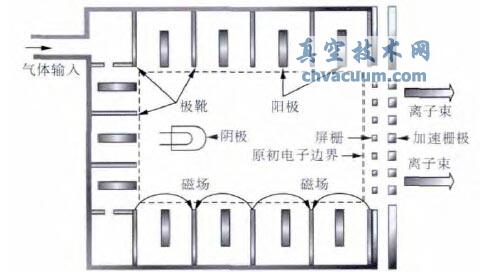
图2 多极考夫曼离子源简图
目前,国产10 cm 直径的考夫曼离子源,加速电压为500-1000 V,可得到约为几个mA/cm2的氩离子束流,其均匀性为±5%,发散角大约为10~15°。若采用小孔、小间距及发散离子光学设计的考夫曼源,并使用辅助电子中和等措施,可以在超低能量区域工作。传统考夫曼离子源的主要缺陷是内置热阴极在活性工作气氛如氧气下工作时,寿命很容易降低。
3、离子束辅助沉积硬质涂层
3.1 、BAD 系统简介
在IBAD 系统中,除上述各种离子源以及必需的真空系统外,另一重要组成部分是提供涂层主要化学成分的气相激发源。综合考虑兼容性、工作气压、能耗等各方面因素,离子源可与电子束蒸发、离子束溅射(双离子源系统)以及磁控溅射等几种PVD 激发源一起组成不同的IBAD 系统,用来制备硬质涂层。
(1)离子束辅助电子束蒸发系统
IBAD 方法是在热蒸发系统上建立的,但在传统的电阻加热装置中,坩埚、加热元件以及各种支撑部件都可能带来污染。在电子束蒸发加热装置中,用于蒸发靶材的高能电子束斑可被限制在毫米量级,靶材的周围被循环水冷却,不会像传统坩埚一样成为污染源。
(2)双离子源系统
所谓双离子源系统,即靶材溅射与辅助沉积均由离子源产生的离子束完成。两束离子源以不同能量分别对靶材、基片进行轰击,达到溅射产额、辅助沉积束流分别可控的目的。当靶材导电性不佳时,可通过直接对离子束提供电子(如前述霍尔离子源)的方法来中和离子束,完成对绝缘靶材的溅射。
(3)离子束辅助磁控溅射系统
磁控溅射与离子源的结合是较新的IBAD技术。磁控溅射沉积速率较快,在保证靶材磁场与离子源磁场互不影响的前提下,可以通过对离子源的单独控制,实现对涂层结构、性能的优化。图5 为阳极层线性离子源辅助磁控溅射制备金属元素掺杂类金刚石(Diamond-like carbon,DLC)涂层的复合系统简图。

图5 离子源辅助磁控溅射系统简图
4、正交电磁场离子源的国内外发展现状
正交电磁场离子源技术经过半个多世纪的发展,在表面工程领域受到越来越多的关注。其结构与功能的主要演变趋势为:1. 电子来源的变
化:提供电子的热灯丝逐渐被能束缚电子做闭合运动的电磁场所取代,解决了灯丝易被污染、在活性气体气氛下服役时间短的问题;2. 离子加速方式多样化:从考夫曼的三栅设计,到霍尔源利用离子的大拉莫运动半径直接引出离子束,离子的加速方式不再是单纯的电场加速,磁场的合理设计实现了无栅网加速;3. 功能进一步细化:正交电磁场离子源种类越来越多,可以实现的功能也各不相同。阳极层线性离子源主要用于镀膜前的清洗过程,现也有辅助沉积方面的应用,考夫曼离子源在大加速电压的使用条件下可以实现离子注入,而霍尔离子源主要用于辅助沉积。
目前,国内市场对离子源需求较大,发展势头良好,但产品仍与国际先进水平存在差距,具体来说主要存在以下几个区别:1. 国产离子源电磁场模拟不够充分:电磁场是离子源设计的关键环节,利用软件对其进行模拟是设计关键部位的必要步骤。在电磁场模拟软件中,ANSYS 仍是主流有限元软件,新兴的COMSOL 在电磁场模拟中也有其独特优势。模拟软件的应用可以大大降低研发成本,促进新技术的出现。2. 国外离子源源体材料更先进:GENCO 公司生产的阳极层线性离子源采用了低溅射产额的石墨作为阳极,延长了阳极的工作周期,此离子源在500 V 时即可以实现聚焦模式工作(传统离子源在2 000 V 以上才会进行模式转变)。SPECS 公司对离子源中的热灯丝进行钇涂层保护处理,防止活性反应气体影响灯丝正常工作。3. 国内离子源加工精度不高:离子源中有些部件对精度要求较高,如考夫曼离子源对屏栅、加速栅尺寸就有严格要求,阳极层线性离子源放电通道宽度也直接影响其工作性能。
5、结论
离子束辅助沉积在氮化物、含碳元素、硼化物等各种体系的硬质涂层中都有广泛应用。其功能主要表现在:
1. 摸索较窄的工艺窗口:特定相结构的形成存在一定的工艺窗口,离子源的可控性是准确摸索工艺窗口的有利条件。通过改变离子能量、束流大小、入射方向等参数,能更全面地分析涂层相的形成条件;
2. 在低温条件下提供相结构形成的能量:在硬质涂层沉积过程中,当基体对温度有限制时,离子束沉积可以在保证低温的同时形成局部的高温高压条件,促使粒子越过能垒;
3.反溅射功能用于提高结合力、减少杂质元素。综上所述,正交电磁场离子源结构简单、方式多样、成本低廉,在硬质涂层沉积方面应用前景广阔。







