反应磁控溅射的机理与特性
近代工程技术的发展越来越多地用到各种化合物薄膜,化合物薄膜约占全部薄膜材料的70%。制备化合物薄膜可以用各种化学气相沉积或物理气相沉积方法,过去,大多数化合物薄膜采用CVD方法制备。CVD 技术目前已经开发了等离子增强CVD,金属有机化合物CVD 等新工艺。但因CVD方法需要高温,材料来源又受到限制,有的还带毒性、腐蚀性,污染环境以及镀膜均匀性等问题,一定程度上限制了化合物膜的制备。
采用PVD方法制备介质薄膜和化合物薄膜,除了可采用射频溅射法外,还可以采用反应溅射法。即在溅射镀膜过程中,人为控制地引入某些活性反应气体,与溅射出来的靶材物质进行反应沉积在基片上,可获得不同于靶材物质的薄膜。例如在O2 中溅射反应而获得氧化物,在N2或NH3 中获得氮化物,在O2+N2 混合气体中得到氮氧化合物,在C2H2 或CH4 中得到碳化物,在硅烷中得到硅化物和在HF 或CF4 中得到氟化物等。目前从工业规模大生产化合物薄膜的需求来看,反应磁控溅射沉积技术具有明显的优势。
1、反应溅射的机理
反应溅射的过程如图1所示。通常的反应气体有氧、氮、甲烷、乙炔、一氧化碳等。在溅射过程中,根据反应气体压力的不同,反应过程可以发生在基片上或发生在阴极上(反应后以化合物形式迁移到基片上)。当反应气体的压力较高时,则可能在阴极溅射靶上发生反应,然后以化合物的形式迁移到基片上成膜。一般情况下,反应溅射的气压比较低,因此气相反应不显著,主要表现为在基片表面的固相反应。通常由于等离子体中的流通电流很高,可以有效地促进反应气体分子的分解、激发和电离过程。在反应溅射过程中产生一股较强的由载能游离原子组成的粒子流,伴随着溅射出来的靶原子从阴极靶流向基片,在基片上克服薄膜扩散生长的激活阈能后形成化合物,以上即为反应溅射的主要机理。
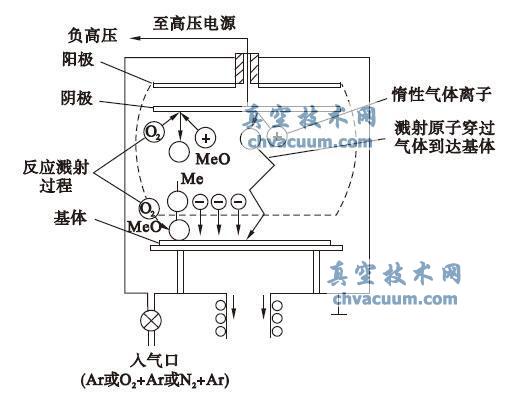
图1 反应溅射原理图
2、反应溅射的特性
反应磁控溅射即在溅射过程中供入反应气体与溅射粒子进行反应,生成化合物薄膜。它可以在溅射化合物靶的同时供应反应气体与之反应,也可以在溅射金属或合金靶的同时供反应气体与之反应来制备既定化学配比的化合物薄膜。反应磁控溅射制备化合物薄膜的特点是:
① 反应磁控溅射所用的靶材料(单元素靶或多元素靶) 和反应气体等很容易获得高的纯度,因而有利于制备高纯度的化合物薄膜。
② 在反应磁控溅射中,通过调节沉积工艺参数,可以制备化学配比或非化学配比的化合物薄膜,从而达到通过调节薄膜的组成来调控薄膜特性的目的。
③ 在反应磁控溅射沉积过程中,基片的温度一般不太高。而且成膜过程通常也并不要求对基片进行很高温度的加热,因此对基片材料的限制较少。
④ 反应磁控溅射适于制备大面积均匀薄膜,并能实现单机年产量上百万平方米镀膜的工业化生产。