等离子体发射监控系统参与的中频孪生反应磁控溅射沉积TiO2薄膜的实验研究
在一个孪生靶实验装置上进行了中频反应磁控溅射沉积TiO2 薄膜的工艺实验。得到了一组真实的反应溅射TiO2薄膜的沉积速率和真空与反应气体流量之间关系的迟滞曲线(无等离子体发射监控系统Plasma Emission Monitoring ,PEM) 参与。介绍了PEM参与下的反应溅射TiO2 的一些实验现象和结果,此时TiO2 的沉积速率与PEM设定值呈很好的线性关系,反应溅射可以稳定在过渡态的任一工作点。设定值是PEM控制系统最关键的参数,直接决定着控制的可靠性、反应溅射速率以及薄膜的微观结构。结果表明,为了得到标准化学配比的反应物,PEM的设定值不能超过某个极限值。要在保证化学配比也就是反应物的成分或结构的前提下提高沉积速率才有意义。
近年来TiO2是热门的薄膜研究和应用材料之一,具有良好的光学、电学、热学、机械性能和化学热稳定性,广泛用于光催化—光降解、太阳能电池、减反射膜和防雾—防露薄膜等领域。TiO2 的制备方法很多,例如溶胶-凝胶法、喷涂法、化学汽相沉积法和磁控溅射法等,其中磁控溅射法以其溅射率高、基片温升低、装置性能稳定、操作方便和适于制作大尺寸靶材等优点而成为镀膜工业化生产的首选方案。
磁控溅射又分直流磁控、射频磁控和中频磁控几种。传统上,金属靶的反应溅射几乎是制备TiO2 薄膜的唯一方法(目前国内已有公司研制出导电型TiO2 陶瓷靶) 。无论是直冷还是间冷,金属钛靶都很容易加工,这是其优势。但直流反应溅射存在着严重的阳极消失和靶中毒问题,而射频反应溅射的设备复杂,成本高,沉积速率低,两者都不利于工业化、低成本、快速生产高品质的薄膜。配以中频电源的孪生磁控靶的反应溅射可以得到较高的沉积速率,能有效抑制打火、根除阳极消失,薄膜的缺陷密度较小,中频电源与靶之间的连接比较简单,不像射频电源那么复杂。由于其沉积速率高且成膜质量好,大功率中频电源也易于实现,已应用于大规模生产线,在真空镀膜工业中占据的地位越来越重要。
但孪生靶仅仅简单地配以中频电源,由于反应溅射的滞后效应(hysteresis effect ,也可称为迟滞效应) 和过程不稳定,类似TiO2一类的反应溅射还是无法消除靶中毒的问题(本文对此有实验数据验证) ,工作模式基本上无法稳定在金属与中毒之间的过渡模式(见图1 的滞后曲线) ,只能以低沉积速率运行。
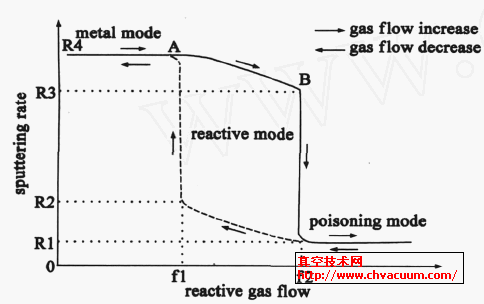
图1 反应溅射的滞后效应曲线示意图
最近发展起来的等离子体发射监控系统(Plasma Emission Monitoring System ,简称PEM) 终于有效解决了反应溅射中靶中毒、沉积速率低等致命问题。PEM的基本思想是磁控溅射辉光等离子体中的某些特征光谱的强度可以线性表征溅射靶面的工作状况,以金属模式下的金属溅射辉光强度为基准,通过监测这些特征光谱在反应溅射时的强度变化可以即时了解靶面的中毒程度,再配以高响应速度的反应气体流量控制器,使反应溅射可以人为稳定在过渡模式中的任何一个工作点且有较高的反应沉积速率———这在没有这种技术前是不可能的。有关PEM的更多介绍可参见真空技术网其它相关文章。
本文在一个孪生靶实验装置上进行了中频反应溅射沉积TiO2 薄膜的工艺实验,得到一组真实的反应溅射沉积TiO2 薄膜的迟滞曲线(沉积速率及真空与反应气体流量的关系,无PEM 参与) ,重点介绍了有PEM参与的反应溅射沉积TiO2 薄膜的一些实验现象和结果。
1、实验
真空系统采用分子泵作为主泵,双泵对称布局。矩形平面孪生靶由我们自行设计研制,两靶面呈V形夹角布置, 靶面有效宽度100mm ( 单幅) , 长度1800mm ,在两靶的中央布局着三个单元的二分布气机构(这种送气机构有响应速度快、各出气口出气流量均匀、稳定等优点, 是专为PEM 系统配置的) 。PEM系统购自于德国的FEP 研究所(Fraunhofer Institute für Elektronenstrahl und Plasmatechnik , Dresden ,Germany) 。图2 所示为本实验中的PEM控制系统等组成示意图。
沉积速率采用美国Inficon公司的XTM/ 2-2100型石英晶体振荡仪进行在线实时监测(可特别用于磁控溅射) 。透射率采用日本岛津制作所的UV-3600 型分光光度计测试。
图2 PEM参与下的反应溅射控制系统示意图
实验中本底真空优于6 ×10 -3 Pa 。溅射时Ar 流量固定为90sccm(分为三路均匀送入,与反应气体在压电阀之后混合,参见图2) ;O2 的流量在PEM 不起作用时,根据需要手动设定(使用北京七星华创的D07 型质量流量控制器) 。PEM参与控制时,由配套的压电阀自动调节。实验中使用的是成都普斯特电气有限公司生产的MSD250 型中频磁控溅射电源(该电源特别设计了恒流、恒压、恒功率三种控制模式,可任意选择) ,实验中将电源的输出频率固定为30kHz ,占空比固定为70 %(该电源的频率和占空比都是可调节的) 。
2、结果与分析讨论
2.1、反应溅射沉积TiO2 薄膜的真实迟滞曲线( 无PEM参与)
滞后现象既存在于直流溅射,采用中频电源也不能幸免,真空技术网介绍的就是中频反应溅射沉积Al2O3 薄膜的迟滞回线,本实验也表明金属靶反应溅射沉积TiO2 薄膜的迟滞现象,见图3。反应溅射中的很多物理参数都具有迟滞现象,比如阴极电压、反应气体分压强、系统(总) 压强、沉积速率、薄膜特性以及等离子体发射光谱等,但最直观的还是阴极电压、系统(总) 压强和沉积速率,其中沉积速率尤为大家所关注,所以本文给出的真实迟滞曲线是以沉积速率为参考标准的,同时在该图中还顺带给出了系统(总) 压强的迟滞曲线。图3 中的坐标沉积速率与横坐标O2 的流量具有在线的一一对应关系,具有直观准确的优点,而非一个流量值对应某个样品然后离线测试所得。不难看出,没有PEM 的参与,要想得到反应完全的TiO2 ,工艺过程只好长期埋没在几乎固定低沉积速率的中毒态。如果为了追求沉积速率而减少反应气体的流量,结果又很可能得到的是Ti而不是TiO2 ,因为减小O2 流量到低于某个值时,反应会突然不受控制地“滑入”金属模式。而欲重新建立正常的TiO2 反应溅射,不但要花费很长时间,所沉积的薄膜的各项指标也很可能根本不对了。