负偏压对多弧离子镀TiN薄膜结构和沉积速率的影响
采用多弧离子镀设备在抛光后的高速钢表面沉积TiN 薄膜,在其他参数不变的情况下,着重考察偏压对薄膜的沉积速率的影响。实验结果表明, 随着负偏压的增加,沉积速率不断增加,但在负偏压达到一定值后,沉积速率又随偏压增大而减小。
TiN 薄膜由于其具有高硬度、低摩擦系数、良好的化学惰性、独特的颜色以及良好的生物相容性等,在机械工业、塑料、纺织、医学工业及微电子工业等领域得到广泛应用,并成为目前工业研究和应用最为广泛的薄膜材料之一。制备TiN 膜的方法很多, 其中多弧离子镀是当今工业上应用最多的技术之一。该技术源于60年代,之后得到了飞速发展。多弧离子镀沉积的薄膜具有膜基附着力强、膜层致密度大、可镀材料广泛、绕镀性好、沉积温度低等许多优点。但是镀膜过程中, 影响膜层质量的因素很多。国内外研究表明影响多弧离子镀的主要工艺参数有阴极靶的工作电流、反应气体压强、基体负偏压、氮气分压及基体沉积温度。
本文主要考察负偏压对沉积速率的影响,当基体被施加负偏压时,等离子体中的离子将受到负偏压电场的作用而加速飞向基体。到达基体表面时,离子轰击基体,并将从电场中获得的能量传递给基体,导致基体温度升高,所以基体负偏压在离子镀中对薄膜的沉积速率、内部的残余应力、膜与基体的结合力以及膜/ 基体系的摩擦性能有显著影响。改变基板负偏压可以调整沉积离子的能量、基片表面的温度,以控制涂层质量。负偏压对多弧离子镀TiN 的结构和性能的影响已有大量的研究报道,但负偏压对薄膜沉积速率的影响,报道较少。本文拟研究负偏压对薄膜沉积速率的影响规律。
1、实验方法
采用抛光后的高速钢作为基体材料。用无水乙醇将试样超声清洗20 min,然后用无水乙醇和丙酮溶液擦拭基体表面,烘干,反复2 次后将其置于SA- 700 6T 多弧离子镀膜系统的基体架上,试样距靶250 mm。真空室抽至本底真空为2.6×10- 3 Pa 时,充氩气到5 Pa~10 Pa,在工件上加负偏压500 V,维持2 min~3 min 后升到900 V。使氩气在低压放电的情况下形成淡紫色等离子体辉光,在电场作用下,氩离子对工件进行轰击清洗。辉光清洗结束后,氩气降至2 Pa 左右,在工件上加900 V 负偏压,点燃Ti 靶,再利用高能量金属离子对基体进行轰击。清洗结束后调整负偏压分别为0 V、- 50 V、- 100 V、- 150 V、- 200 V 和- 250 V,沉积TiN 薄膜。沉积时电弧电压U=20 V,弧流I=65 A,沉积时间均为30 min。采用X 射线衍射仪对薄膜的物相结构进行了分析。扫描电子显微镜对镀层显微组织进行了分析。利用XP- 2 台阶仪对薄膜厚度进行测量。再根据测得的厚度与沉积时间计算出沉积速率。
2、结果与分析
2.1、不同偏压下薄膜的相结构
图1 是薄膜的X 射线衍射图谱,分析表明,薄膜的物相组成是TiN 相,在不加偏压时,可观察到TiN(200)、(220) 晶面所对应的衍射峰,但(111) 衍射峰几乎为0。该谱线中最强峰来自基底Fe(111),表明薄膜厚度较小,X 射线已穿透基底。随偏压增大,开始出现(111)晶面取向,而(200)择优取向相对减弱,当偏压达到200 V 时TiN 薄膜呈现出强烈的(111)择优。我们注意到,Fe(111)峰随偏压升高而逐渐减弱,说明薄膜厚度在逐渐变大。

图1 不同偏压下获得的TiN 薄膜的XRD 衍射图谱
2.2、涂层表面形貌
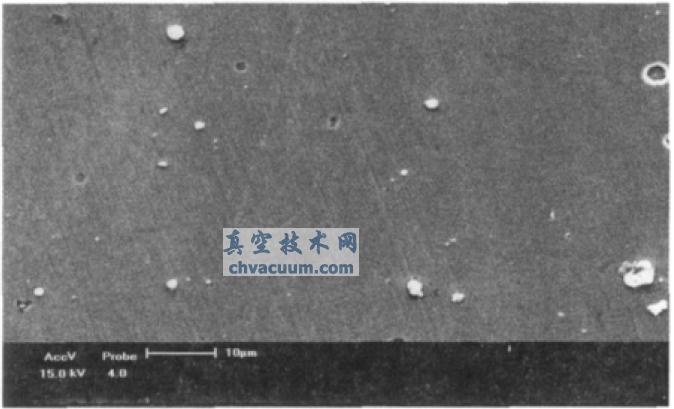
图2 TiN涂层表面形貌
在多弧离子镀镀覆的涂层,其表面均存在着弥散分布的颗粒。普遍认为是靶材在局部电弧高温作用下熔化成微小的液滴并喷发出来,随后以固相颗粒形态附着在涂层表面,这些微区硬度低于TiN 膜层。这些软点对涂层刀具的工作性能是有害的,同时也降低了刀具表面的光洁度。通过扫描电镜可以观察到,TiN 涂层表面颗粒一般在1 μm~2 μm,达到5 μm以上的数量很少。