衬底H等离子体预处理时间对微晶硅薄膜生长的影响
本文采用VHF-PECVD 技术制备了系列硅薄膜,通过椭圆偏振技术及拉曼测试手段研究了衬底表面预处理时间对微晶硅薄膜的微结构及其生长的影响。实验结果表明:随衬底预处理时间(0~10 min)的延长,薄膜的晶化率从14%提高到44%;薄膜表面的硅团簇尺寸减小,在衬底预处理10 min 时,薄膜表面的粗糙度较小。在衬底未预处理与预处理10 min 时,在相同的沉积参数下,沉积两系列不同生长阶段硅薄膜的生长指数接近。原因是H 等离子体预处理使衬底表面的原子氢增多,有利于成膜先驱物在衬底表面的迁移,影响薄膜的初期成核,使薄膜易于晶化。
微晶硅薄膜由于其优良的光电特性,在薄膜晶体管和太阳能电池等领域的应用中,是极其具有吸引力的材料。通常微晶硅薄膜制备技术有射频等离子体增强化学气相沉积技术(RF- PECVD)、热丝化学气相沉积技术(HWCVD)和甚高频等离子体增强化学气相沉积技术( VHF- PECVD)。VHF- PECVD 由于与现有工业技术兼容性好,且具有电子密度高、电子温度低等优点,因此是最具发展潜力的技术。
通常,采用高氢稀释是制备高晶化硅薄膜的有效方法,但高氢稀释不但会增加制备薄膜的成本,而且会降低薄膜的沉积速率,而等离子体预处理衬底可以改善薄膜的初期成核,进而改善薄膜的结构和性能,因此我们有兴趣研究通过等离子体预处理衬底来优化薄膜的生长。
本文我们采用VHF- PECVD 技术在玻璃衬底上制备了系列硅薄膜,研究了H 等离子体预处理衬底不同时间对微晶硅薄膜的结构和生长的影响。
1、实验
采用VHF- PECVD 技术在玻璃衬底上制备了系列硅薄膜。氢等离子体预处理条件如下:气压300 Pa, 功率密度0.35 W/cm2, 总气流量120 SCCM,预处理时间分别为0、5、10、30、50 min。硅薄膜沉积参数分别为:激发频率75 MHz,电极间距1.5 cm,背景真空在4×10- 4 Pa 左右,衬底温度220 ℃,硅烷浓度SC = [SiH4] / ([H2] + [SiH4]为3%,沉积气压200 Pa,气体总流量150 SCCM。衬底未预处理与预处理10 min,沉积时间分别为10、13、15、20、25 min。
薄膜表面形貌观察采用扫描电子显微镜(SEM)。薄膜微结构分析采用拉曼散射光谱仪(RS)和椭圆偏振光谱仪(SE)。椭偏光谱测量采用美国J.A. Woollam 公司生产的VASE 型椭偏谱仪,测量时入射角固定为70°, 在光谱波段范围为240~1000 nm 内,以10 nm 为波长间隔,测量得到薄膜的椭偏参数ψ 和Δ 值,使用WVASE32 软件对数据进行分析处理。
2、结果和讨论
为了了解衬底H 等离子体预处理时间对微晶硅薄膜结构的影响,我们对衬底进行H 等离子体预处理后,在同一沉积参数条件下沉积了等厚的微晶硅薄膜,并对样品做了拉曼光谱和椭偏光谱测试。
图1 为衬底H 等离子体预处理不同时间后,在其上沉积了5 min 的微晶硅薄膜的拉曼散射光谱。由图1 可以看出,随衬底预处理时间的延长,薄膜的晶化率逐渐提高,预处理时间从0增加到10 min 时,晶化率从14%提高到44%,薄膜的微结构从接近非晶逐渐向微晶过度。
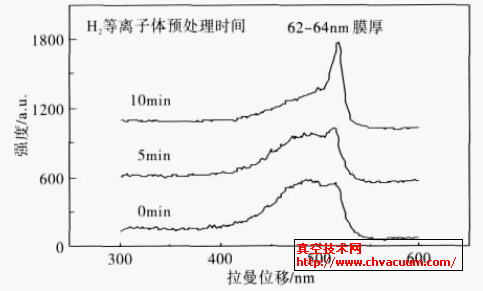
图1 衬底H 等离子体预处理不同时间的微晶硅薄膜的拉曼散射光谱,薄膜厚度大约62~64 nm
图2 为对衬底进行H 等离子体预处理不同时间后,在其上分别沉积了5 min 的微晶硅薄膜的SEM 形貌。由图2 可以看出,衬底未预处理时,薄膜的硅团簇颗粒较大,随衬底预处理时间的增加,硅团簇颗粒尺寸逐渐减小,密度增大,当对衬底预处理时间为10 min 时,团簇颗粒较小,薄膜表面较为平整。产生上述现象的原因可能是适当H 等离子体预处理使衬底表面的原子氢增多,提高了成膜先驱物在衬底表面的迁移,有利于薄膜的初期成核,使薄膜易于晶化。
图2 H等离子体预处理不同时间后沉积微晶硅薄膜的SEM形貌 图3 衬底未预处理时沉积微晶硅薄膜的SE 光谱
为了了解衬底表面预处理时间对薄膜生长行为的影响,我们对样品做了椭圆偏振光谱测试,如图3 所示。