氢化微晶硅薄膜的两因素优化及高速沉积
采用甚高频等离子体辅助化学气相沉积技术(VHF-PECVD) 分别对薄膜沉积参数进行了功率密度—沉积气压和硅烷浓度—气体总流量两因素优化。主要研究沉积参数对薄膜沉积速率和结晶状况的影响,结果表明:高沉积压强下,功率密度的提高对微晶硅薄膜(μc-Si∶H) 沉积速率的影响减弱,硅烷浓度和气体总流量影响作用相对增强,高硅烷浓度有利于材料的利用,最终在高压强(600Pa) 条件下,使微晶硅薄膜的沉积速率提升到2.1nm·s - 1 。同时,利用分步沉积法对薄膜的纵向结构均匀性进行了初步研究。
近年来,在太阳能薄膜电池领域,微晶硅薄膜被认为是最有应用前景的材料之一。在太阳能薄膜电池应用上,与非晶硅相比,它克服了光致衰退问题。但微晶硅薄膜是间接带隙半导体材料,光吸收系数较低,用作太阳能电池有源层(本征层) 时,为了有效地吸收入射光,厚度需要1μm~2μm。因此,高速沉积微晶硅薄膜便显得极为重要。
甚高频等离子辅助化学气相沉积(VHF-PECVD) 结合高气压高功率被认为是高速沉积微晶硅薄膜最有效的方法之一,但存在驻波效应易导致薄膜沉积不均匀,不利于大面积沉积,南开大学已利用多点馈入来改善这一缺点。同时影响薄膜沉积的宏观参数较多也制约着这一技术的应用。到目前为止,已有许多文献报道了单一沉积参数对薄膜沉积及其性能的影响,并对沉积进行了单因素的优化。考虑到影响薄膜沉积的各参数之间存在着相互影响,在高速沉积中为了更加全面详细地研究各个参数所起的作用,本文采用了两参数优化的方法沉积了大量的微晶硅薄膜,并对薄膜的结构均匀性及改进进行了初步研究。
1、实验
所有样品均在平行板电容方式耦合的VHF-PECVD 系统的本征室制备。设定激发频率为75MHz ,温度为220 ℃,衬底采用载玻片(实验中发现可有效减少薄膜剥落现象的发生) 。在保持以上参数不变的情况下,通过改变硅烷浓度(SC = [ SiH4 ]/[SiH4 + H2 ]) 、沉积气压、功率密度和气体总流量的大小制备了一系列微晶硅薄膜,重点观察硅烷浓度、沉积气压、功率密度和气体总流量对生长速率、结晶状况的影响。用分光光度计(日本岛津UV-3150) 测量薄膜的厚度;用拉曼谱仪(Renishaw 2000) 表征材料的结晶状况,并对材料的拉曼谱进行了三峰高斯拟合,用积分强度比XC = ( I510 + I520)/( I510 + I520 +I480) 来估算材料的晶化率。式中I520是晶硅的特征峰强度, I480是非晶硅的特征峰强度, I510一般被认为是小晶粒散射产生的; 电导率和激活能由keith-ley6517 繁用表测得。
2、结果讨论与分析
2.1、功率密度与沉积气压对薄膜生长的影响
功率密度的提高,有助于提高电子温度和电子密度,因而分解产生的成膜前驱物和氢原子增多,导致沉积速率增加和晶化率提升。但功率密度过高也将产生大量的高能离子和过多的氢原子,氢原子对生长表面的过多占用和高能离子对表面的“刻蚀”,达到一定程度会导致沉积速率和晶化率的降低,出现“硅烷耗尽”状态。沉积气压的提高,一方面提高了硅烷分子和电子密度,另一方面又降低了电子温度。两方面因素共同作用于薄膜的生长,随着宏观沉积参数的不同会出现不同的变化规律。图1 所示是频率75MHz、硅烷浓度为4 %、气体总流量60sccm、极板间距115cm 条件下的功率密度- 沉积气压生长相图。图中用同心扇形环表示生长速率和晶化率,内环表示生长速率(一整圈表示1nm·s - 1的生长速率) ,外环表示晶化率(一整圈表示100 %的晶化率) 。图中黑色弧线表示非晶和微晶的分界线。
在压强不变条件下,随功率密度的提升,生长速率和晶化率逐渐提高。450Pa 条件下, 在0.55W·cm- 2时沉积速率趋于饱和,达到硅烷耗尽状态,随后沉积速率略有降低。在功率密度不变条件下,随压强的提升,在350Pa 出现最大值,进一步提升沉积压强,生长速率先减小再增大,但增大幅度很小,并未明显大于350Pa 时的生长速率。我们认为是在低流量、高功率、高压强条件下,由于硅烷分解已相当充分,提升压强并不能明显提升成膜先驱物的数量。
从图中还可看出,在压强为400Pa 和450Pa 时,当功率密度达到一定值后,气压的变化对晶化率和沉积速率的影响变小。在我们的另一组气压分别取500、550、600、650、700Pa 的实验中(硅烷浓度4 %、功率密度0.60W·cm- 2 、气体总流量100sccm、间距110cm) 也出现晶化率和沉积速率几乎不变的现象。
分析认为出现这一现象主要是由于硅烷绝对量较小,在高气压下分解率已相当大,因而单纯提高功率和压强并不能提高沉积速率,此时要想继续提升沉积速率,可以采用增加气体流量或提高硅烷浓度的方法。
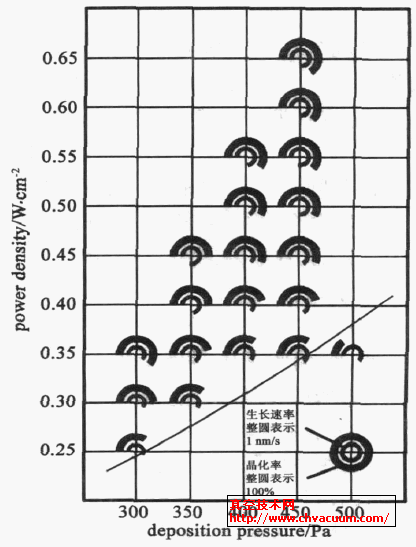
图1 功率密度- 沉积气压生长相图
限于篇幅,文章中间章节的部分内容省略,详细文章请邮件至作者索要。
2.4、分步沉积法对纵向结构的影响
沉积薄膜的纵向结构不均匀会影响薄膜的纵向电学特性,最终影响电池的性能。为了改善薄膜的纵向结构不均匀性,实验中常用的方法是采用分步沉积,方法为:首先用容易结晶成核的低速沉积参数沉积,用以减小孵化层厚度,然后改变沉积参数为高速沉积的条件,以实现高速沉积。理论上分的步数越多,沉积的薄膜纵向均匀性会越好,但每一步都需要对沉积参数和沉积时间进行优化,如果分步数过多,会导致参数优化难度加大。但是,当分步步数过少时,沉积条件的突变可能会产生新的界面,从而违背实验的初衷。在硅烷浓度—气体总流量两因素相图的基础上,我们采用硅烷浓度分步沉积的方法对分步沉积进行了初步尝试,沉积分三步进行。
第一步, 硅烷浓度2.5 %、功率密度0.60W·cm- 2 、沉积气压500Pa 、气体总流量200sccm、间距110cm ,沉积时间5min。
第二步,硅烷浓度3.0 % ,其它条件不变,沉积时间为3min。
第三步,硅烷浓度3.5 % ,其它条件不变,沉积时间为4min。
考虑到单个沉积条件沉积的薄膜中也存在纵向结构不均匀性,所以我们又用第一步所用条件分别沉积了2min 和5min 制备出两个样品,随后在第一步沉积5min 的基础上,再用第二步所用条件沉积了2min 和3min 制备出两个样品,最后,当第一步、第二步沉积完成后,用第三步所用沉积条件分别沉积2min 和4min 制备出两个样品。共制备了六个样品来研究分步沉积对纵向结构的影响。

图5 分步沉积中晶化率随时间的变化规律
图5 所示为分步沉积中晶化率随时间的变化规律,用阴影区分出不同沉积条件的三步。从图中可以看出当第一步沉积完成后,第二步和第三步沉积过程中薄膜的晶化率几乎保持不变,从而极大地改善了单一沉积条件下沉积的薄膜所出现的随着沉积薄膜厚度的增加,晶化率越来越大的现象,同时也可以看出在每次改变沉积条件后,分步沉积中沉积条件的改变并没有导致晶化率出现明显改变,因而说明不存在明显的界面,说明薄膜纵向结构一致性较好。
3、结论
首先绘制了功率密度—沉积压强两因素沉积相图,从相图中得出:在高沉积压强条件下,高的功率密度必须和高硅烷浓度或足够大的气体流量结合,才能提升沉积速率。当硅烷浓度和气体总流量一定时,仅靠提高沉积功率和沉积压强对沉积速度的提升没有明显作用。随后我们又绘制了硅烷浓度—气体总流量两因素相图,从中发现硅烷高浓度结合小气体流量,不仅可以提升沉积速率,而且气体利用率也得到提高,在硅烷浓度为4. 5 % ,气体总流量为100sccm 条件下薄膜沉积速率为1. 42nm·s - 1 ,晶化率为35 % ,暗电导为8. 7 ×10 - 8 (Ωcm) - 1 ,电导激活能为0.47eV。在提升沉积速率方面,最终在600Pa高压强条件下,使微晶硅薄膜的沉积速率提升到2.1nm·s - 1 。但研究发现,高沉积速率条件下沉积的薄膜具有较厚的孵化层,需要采用一定的工艺来进一步优化。在硅烷浓度—气体总流量两因素相图的基础上,我们初步尝试了采用不同的硅烷浓度分步沉积,发现对改进薄膜纵向均匀性效果明显,对其它性能的影响有待进一步研究。