热丝CVD低温下快速制备碳化硅基硅纳米晶薄膜的研究
采用热丝化学气相沉积(HWCVD--Hot Wire Chemical Vapor Deposition)技术在低温下制备碳化硅基硅纳米晶(Si-NC:SiC --Si NanoCrystal embedded in Silicon Carbide)薄膜。研究了CH4 与总气体流量比R(CH4/[CH4+H2+SiH4])对薄膜生长过程及薄膜特性的影响。通过X 射线衍射仪、透射光谱等对薄膜的结构、光学带隙及生长速率进行了表征。结果表明所制备的薄膜具有Si-NC :SiC的结构特征,纳米晶硅大小16nm至8nm。随着R由5%增加到25%,薄膜的生长速率由21.3nm/min 减小到13.6nm/min,薄膜的光学带隙由2.01eV增加到2.19eV。从反应气体在热丝处的分解过程及Si-NC :SiC 薄膜生长机理分析了以上实验结果。
0、引言
碳化硅基硅纳米晶(Si-NC :SiC)薄膜是第三代全硅叠层高效太阳能电池最适合的顶层材料之一,具有禁带宽度可调、光吸收系数大、载流子传输效率高等特点。这些独特的性能也使得Si-NC :SiC 在敏感器件、记忆存储器件等方面具备广泛的应用前景。目前广泛采用的Si-NC :SiC 薄膜的沉积方法是2002 年M. Zacharias[5]提出的低温沉积+高温退火法,即低温下采用气相沉积法(PECVD、溅射、热分解等)交替制备富硅的介质层和符合计量比的介质层,再用高温长时间退火诱导富硅介质层中的Si 析出,从而形成Si-NC。这一方法的优点是可以通过交替沉积层的厚度来较好地控制量子点的尺寸及分布,然而存在着许多关键问题,比如较高的退火温度会影响材料的性能、工艺控制较为复杂且难、生长过程中容易产生SiC 绝缘层会降低量子点密度和增大串联电阻等。
近几年随着研究的深入,一些研究小组开始使用PECVD 法制备Si-NC :SiC 薄膜并得出了大量研究结果,然而这种方法仍存在着几个致命缺点,例如沉积速率较低(一般均小于3nm/min)、较高的薄膜损伤率、较低的量子点密度、量子点间距和尺寸难以控制等等。热丝化学气相沉积(HWCVD)法与PECVD 法相比具有气体分子离解率高的特点,因此可以获得较高的沉积速率。除此之外,HWCVD 法的优势还包括:第一,无离子损伤;第二,设备容易放大,均匀性好,薄膜的台阶覆盖率高,气体利用率可达到80%(远高于PECVD 的10%)等。这些优点决定了HWCVD 法很有希望成为一种有效的Si-NC :SiC 薄膜制备方法。事实上,真空技术网(www.chvacuum.com)之前的文章已经有报道指出,在H2/SiH4+CH4 < 30 这样较低的稀释比下,可以通过HWCVD 制备出Si-NC :SiC 薄膜。
本项工作主要是利用HWCVD 法开展Si-NC :SiC 薄膜低温沉积研究。在此介绍一些初步研究结果,主要是热丝温度、衬底温度及气体配比对Si-NC :SiC 薄膜生长速率、光学带隙及硅纳米晶尺寸的影响。
1、实验
Si-NC :SiC 薄膜采用HWCVD 系统制备,热丝直径为0.4mm,长度为145mm,钨丝和沉底的距离固定在40mm。生长中,衬底温度TS 分别采用250℃和300℃,钨丝温度TF 分别为1800℃和1900℃,反应室内总压强维持在50Pa,腔体背低真空达到5×10-3 Pa。反应气体采用纯度为100%的CH4 气体和高氢稀释的SiH4 气体(稀释度RH=H2/[H2]+[SiH4]=95%),实验过程中,SiH4+H2 气体流量固定在5sccm,改变CH4 的流量使得CH4 气体比例R=[CH4]/[CH4+SiH4+H2]分别取5%,15%,25%。薄膜沉积在#7095 玻璃上,沉积时间为60min。实验参数如表1 所示。
表1 沉积参数
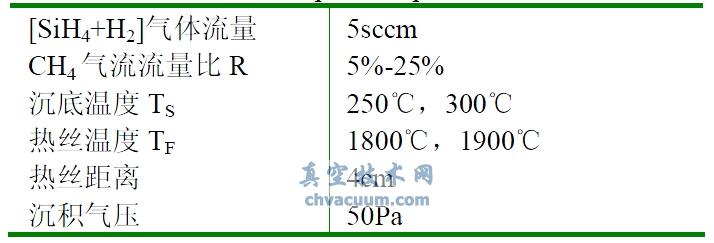
采用X 射线衍射仪(XRD)测试了薄膜的结构(X 射线衍射仪的型号为SHIMADZUXRD-6000,采用Cu 靶,辐射波长λ =1.5406Å,管电压为40KV,管电流为30MA,扫描速度为4°/min)。采用岛津UV-2550 分光光度计测试样品的透射光谱,计算了薄膜的光学带隙和薄膜的厚度,通过计算薄膜厚度除以生长时间计算出薄膜的沉积速率。
2、结果与讨论
2.1、X 射线衍射(XRD)
图1为热丝温度TF=1900℃,衬底温度TS=300℃,不同CH4气体比例下的X射线衍射图。图中28.4°,47.3°和56.1°处的三个峰分表代表了Si(111),Si(220)以及Si(311)晶面,其中Si(111)峰的衍射强度要远远高于其他两个峰,原因是Si(111)晶面具有较低的表面能,并且是Si晶面中的最密排面。从图中还可以看到是随着CH4气体比例的由5%增加至25%,Si(111)峰的衍射强度不断降低,当R=25%时,XRD曲线中除了很弱的Si(111)衍射峰外,几乎都是非晶峰,这说明随着CH4气体比例的增加,薄膜结构中非晶相增多。在硅(111)方向衍射峰强度减小的同时,其半峰宽增大,由Scherrer公式估算出对于甲烷比例为5%,15%,25%的薄膜晶粒大小约为16nm,10nm和8nm,这说明Si纳米晶尺寸随着CH4比例的增加而减小。

图1 不同CH4 气体比例下的XRD 图
在50°和80°之间有个非晶包,其中包含了SiC 的非晶峰向。但在整个图中并没有出现明显的晶态SiC 或C(金刚石或石墨)的衍射峰,这说明大部分C 可能与Si 相结合形成非晶态的SiC[12],整个薄膜结构应该是非晶的碳化硅包围着纳米晶硅颗粒。