磁控溅射薄膜生长全过程的计算机模拟研究
本文通过建立多尺度模型,结合模拟了磁控溅射中溅射原子的产生、溅射原子的碰撞传输、以及最终成膜的全过程,研究了基板温度、溅射速率、磁场分布和靶材-基板间距对薄膜生长过程与薄膜性能的影响。模拟结果显示,提高基板温度或降低溅射速率都会增加初期生长阶段薄膜的相对密度;磁场对靶的利用率有显著的影响,而对薄膜最终形貌的影响不大;增大靶材-基板间距会降低薄膜的粗糙度。
磁控溅射自20 世纪70 年代诞生以来,因较高的沉积率和成膜质量而成为薄膜制备的重要手段之一,被广泛应用于集成电路制造、特殊功能材料涂层以及材料改性等诸多领域。由于当前溅射成膜工艺的控制在很大程度上仍然依赖于实验经验,因此,模拟研究磁控溅射生长过程,对辅助溅射成膜工艺的实际操作有着重要的意义。
随着计算机技术的迅猛发展,计算物理方法与传统的理论研究和实验研究的结合日趋紧密。许多国内外研究成功运用计算机模拟方法探讨薄膜的生长机理,并提出多种模拟手段来重现与薄膜生长相关的物理过程,例如Smereka 等对晶面生长速度的研究;Volter 运用10原子环形模型对薄膜生长过程的模拟 ; Daw 和Baskes等提出了嵌入原子方法(EAM-embedded atom method) 用以计算势函数,并将其应用于对面心立方晶体微观性能的描述。然而,磁控溅射中各部分物理过程在空间和时间尺度上跨度较大,这样多尺度问题的计算机模拟并不容易,因此对磁控溅射沉积薄膜全过程模拟的研究报道并不多见。在现有的个别全过程模拟方法中,通常对成膜过程进行一定的简化,例如不涉及迁移和脱附等物理过程,这对模拟的精确性会产生一定的影响。
本文建立了一个多尺度模型,对磁控溅射薄膜生长的全过程进行了计算机模拟,研究了基板温度、磁场分布及靶材- 基板间距对成膜的影响。首先应用PIC ( Particle-In-Cell)对溅射原子的产生进行模拟 ,并得到靶的刻蚀曲线;其次应用蒙特卡罗(MC Monte Carlo) 方法模拟原子在空间的碰撞传输过程;跟踪原子到达基板后,利用蒙特卡罗方法对薄膜微观生长过程进行三维模拟;最后采用带电云方法(CIC Clouds In Cells) 得到薄膜宏观形貌图。结果显示,初期生长阶段,薄膜的密度随着基板温度的增加而增加,随着溅射速率的增加而减小;薄膜宏观形貌与靶的刻蚀曲线密切相关———薄膜最大厚度出现的位置与靶的刻蚀最深处相对应;随着基板温度的增加薄膜的厚度逐渐减小,而随着靶材- 基板间距的增大,薄膜的厚度和粗糙度均会减小。
1、模型与方法
磁控溅射成膜过程由以下三个过程组成:
(1)溅射原子的产生———通过控制靶材上加载的电压激发辉光放电,利用产生的离子对靶进行轰击,得到溅射原子;
(2)溅射原子的传输———溅射原子在向基板运动的过程中,会不断地与背景气体发生碰撞,最终到达边界或基板;
(3)原子在基板上的沉积———原子到达基板后,在基板表面发生吸附、迁移、脱附等物理过程,最后沉积在基板表面,形成薄膜。
本文中模拟的放电真空腔为圆柱形,其结构示意图如图1 所示。圆形的薄膜沉积基板(Substrate) 位于真空腔的顶部;同样为圆形的溅射靶(Target ) 位于真空腔的下方;圆柱形中心磁极(S) 及圆环型外围磁极(N) 则位于真空腔的底部,溅射靶的正下方。如图所示,真空腔内径R 为42mm,薄膜沉积基板半径为40mm,溅射靶半径为26mm,中心磁极半径为6mm,外围磁极截面宽度为5mm,两磁极间距15mm,靶材与基板的间距为Z 。基板接地作为阳极,靶为阴极加直流负偏压( - 450V) ,二次电子发射系数为0.3 ,背景气体为氩气,初始等离子体密度n = 1 ×1013m- 3 。径向边界(0 ≤z ≤Z , r = R) 处为金属,边界上仅具有法向电场,其初始值为零,电场强度随粒子流产生的壁电荷的累积而变化。模拟中采用的空间分辨率Δr=1mm、Δz=2mm ,时间步长Δt = 1 ×10-10s。
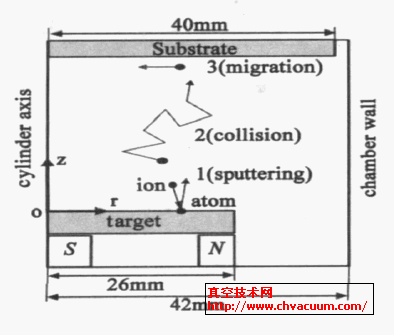
图1 磁控溅射结构示意图
限于篇幅,文章第二章节的部分内容省略,详细文章请邮件至作者索要。
3、结论
本文结合了PIC ,MC , EAM,CIC 等方法对整个等离子体磁控溅射成膜过程进行了多尺度的计算机模拟,并系统研究了磁控溅射成膜过程中基板温度、磁场分布、靶材-基板间距等参数对成膜的影响。研究结果表明,
(1) 随着基板温度的提高,薄膜初期生长阶段所形成的岛的尺寸增大而岛的数量减少,相对密度提高。但提高温度的同时,也会使沉积原子的脱附率升高。因此实际中需要根据材料性质、质量和成本来选取最合适的基板温度。
(2) 磁场分布对靶的刻蚀曲线有较大的影响,而对薄膜最终形貌影响甚微。研究表明,flat 型磁场可以在不影响薄膜成膜的前提下最大程度地提高靶材的利用率。
(3) 随着靶材-基板间距的增大,薄膜的成膜速率以及薄膜的粗糙度均会减小。
本文工作是关于磁控溅射成膜过程的初步研究,尚有一些问题,诸如衬底材料及表面状态(晶向、平整度) 等对薄膜初期生长过程的影响,都有待更完善的物理模型进一步深入研究。