RF-PECVD制备类金刚石膜的研究
采用RF- PECVD 法在锗(Ge)基片上沉积类金刚石(DLC)薄膜,研究了气体流量和气压对沉积区域均匀性的影响,以及基片厚度与沉积时间的关系。用拉曼光谱(Raman)分析DLC 膜的结构组成,用傅立叶红外光谱仪(IR)对DLC 膜的透过率进行了测量。结果表明,在气体流量为50 sccm,气压为10 Pa,功率800 W条件下薄膜厚度均匀性可达2.1%,极值透过率达62%。
随着红外技术的发展,在红外窗口材料上镀制8 μm~12 μm 波段高性能红外增透膜,从而提高红外信号的透过率,提高红外探测器的分析灵敏度,实现红外探测和制导,是目前受到普遍关注的领域。锗(Ge)是在8 μm~12 μm范围内最常用的窗口和透镜材料,但容易被沙粒划伤和被海水侵蚀。类金刚石膜(DLC)在8 μm~12 μm范围内具有与Ge 相匹配的折射率和很高的透过率,
且因其具有高硬度,耐摩擦,高绝缘,耐酸碱的能力,是Ge 透镜的理想增透材料和保护膜层,因此在Ge 上镀制均匀,性能良好的类金刚石膜非常重要。
射频等离子体增强化学气相沉积(RF-PECVD)是目前最常用的DLC 膜沉积方法之一。该方法具有沉积温度低、沉积面积大,沉积速率高,膜层质量好,适于在介质基片上沉积等优点。它虽可用来制备光洁度高的光学级类金刚石薄膜,但对于大口径零件来说存在膜层均匀性的问题,这是在国内普遍存在的问题。为降低沉积过程中由于高能粒子对基底的轰击引起基底温度升高,从而对膜的结构产生较大影响,本文采用两次沉积的方法完成DLC 膜的制备。以甲烷(CH4)为气源,研究了气体流量和气压对薄膜均匀性的影响以及基片厚度与沉积时间的关系。
1、实验
制备DLC 膜的装置采用上下极板电容耦合的方式,上下极板直径比为9/4,极板间距65 mm,激励电源为频率13.56 MHz,功率2 kW 的射频源。基片大小Φ22×(1~3)mm,均为镜面抛光的单晶Ge。
将用无水乙醇擦拭干净的单晶基片放入下极板指定位置后,抽真空至小于1.5×10- 2 Pa,通入Ar 气,保持气体压力3.3 Pa~4 Pa,功率200 W,清洗基片5 min。然后通入甲烷(CH4),气体流量40 sccm~50 sccm,工作压力7 Pa~20 Pa,800 W 左右的功率下沉积15 min~20 min。然后关闭电源,冷却10min 钟后,取出锗片,清理腔体。再次放入锗片,抽真空至1.5×10- 2 Pa,用Ar 清洗2 min后,在相同条件下沉积15 min~20 min。
用英国Renishaw RM1000 型拉曼光谱仪(Raman) 对样品的结构组成进行分析,用美国Nicolet6700 傅立叶红外光谱仪(IR)对透过率进行测量。
2、结果与讨论
为研究甲烷流量和工作气压对不同半径处DLC 膜厚度的影响,我们将4 个Φ22×2.5 mm的Ge 基片放在如表1 所示位置。表1 为4 个不同流量和气压条件下制备的样品的均匀性结果,4 次试验中,都保持沉积功率为800 W,两次沉积时间共30 min。可以看到,当气压为20 Pa,气流为40 sccm 时,DLC 膜非常不均匀,且中间薄边缘厚。降低气压至10 Pa,均匀性为10%。再增加气流至50 sccm,DLC 膜均匀性大幅提高,为2.1%。继续降低气压至7 Pa,DLC 膜不均匀性有所增加,且为中间厚边缘薄,此时薄膜的生长速率也有较大下降。
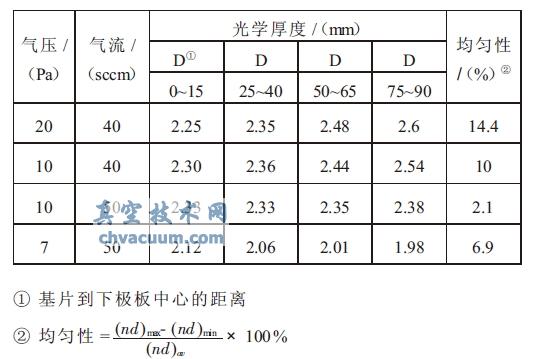
表1 不同条件下制备的DLC 膜的均匀性

图1 基片厚度与沉积时间的关系图
相同实验条件下在不同厚度的Ge 基片上沉积DLC 膜时发现,若要制备出相同光学厚度的DLC 膜,总共沉积时间有差异。图1 为在功率为800 W,气压为10 Pa,气体流量为50 sccm 的固定条件沉积光学厚度为2.35 mm 的DLC 膜时,基片厚度与总共沉积时间的关系图。可以看到,当基片较薄,所需沉积时间较长,为39 min。随着基片厚度的增加,沉积时间大幅减少。当基片为2.5 mm厚时,沉积时间只需30 min。但随着基片厚度的继续增加,沉积时间又有所增长。值得说明的是,1 mm~3 mm 厚的基片在下极板的各个径向位置厚度均匀在5%以内。

图2 样品的拉曼光谱
Raman 是分析DLC 膜结构组成的最好方法,图2 为Φ22×2.5 mm 的Ge 基上沉积30 min 的DLC 膜Raman 光谱图。从图2 可以看出,在1000 cm- 1~1800 cm- 1 范围内存在一个很强的非对称宽峰,表明薄膜具有典型的DLC 薄膜的特征[8]。DLC 膜的拉曼光谱按高斯拟合成两个峰,位于1536 cm- 1 附近的较强宽峰,对应于G 峰;位于1342 cm- 1 附近的肩峰,对应于D 峰。G 峰与链状的C- C 键相关,表征键角发生畸变的非晶态,与单晶石墨的G 峰(位于1580 cm- 1)相比,该峰向低频方向有移动。宽化的D 峰源于碳膜内含有畸变的四价杂化的sp3 键,且ID/IG 为0.70。通常认为Raman 中G 峰位峰向低波数漂移且ID/IG 值较小的现象意味着薄膜中sp2 杂化碳减少,sp3 键数量增加。

图3 样品的实测透过率
图3 为Φ22×2.5 mm的Ge 基上沉积30 min 的DLC 膜的透过率曲线。由于光的干涉作用,大大降低了样品在参考波长附近的反射损失,从而提高了红外透过率。从图可知,平均透过率在60%左右,极值透过率达62%。
3、结论
用RF- PECVD 法在Ge 单晶上成功镀制了DLC 薄膜。甲烷流量和工作气压对薄膜的均匀性有很大影响,且沉积时间与基片厚度密切相关。DLC 膜的平均透过率为60%。目前我们已实现Φ180 mm 内的Ge 基片上制备DLC 膜的小批量生产。