新型弧光辉光协同共放电(APSCD)真空镀膜机的研制
本文阐述了新型的弧光辉光协同共放电真空镀膜机的设计思想及应用,叙述了镀膜机的整体结构、圆柱靶的设计和磁场模拟、工件篮的结构和辉光弧光共放电的原理。实验对比了辉光弧光共放电和单独的辉光放电、弧光放电在镀膜速度、膜层硬度和耐蚀性等方面的差别,表明了这种新型镀膜机的优越性。
采用物理气相沉积(PVD)镀膜技术制备的膜层具有高硬度、高耐磨性(低摩擦系数)、很好的耐腐蚀性和化学稳定性等特点,同时膜层还能够提高工件的外观装饰性。PVD 是一种能够真正获得微米级镀层且无污染的环保型表面处理方法。它能够制备各种单一金属膜(如铝、钛、锆、铬等),也可以制备氮化物膜TiN(钛金)、ZrN(锆金)、CrN、TiAlN 和碳化物膜(TiC、TiCN)、以及氧化物膜(TiO)等陶瓷薄膜。基于PVD 制备技术的纳米超硬膜、耐蚀膜已成为涂层领域研究开发的热点,自2000 年以来在国内已进入持续开发阶段。众所周知,金刚石、立方氮化硼、非晶态类金刚石等具有超硬膜的本征硬度,其研究及应用已经历了较长时间,但其膜系本身的某些特性却制约了应用领域的拓展。如金刚石薄膜并不适合于铁基材料的切削加工,而立方氮化硼薄膜由于难于与刀具基体结合、易剥落,且高纯度的c- BN制备困难,也尚未达到商业应用水平。因此近年来薄膜技术的开发热点更多的集中于非本征超硬膜的研究。非本征硬度超硬薄膜的超硬性和力学性能主要来自于它们组成物的性质和超细显微结构,其组成物多为氧化物、碳化物、氮化物及硼化物,而其显微结构达到了纳米数量级。
对于工业应用的耐蚀膜包括耐磨蚀和耐环境腐蚀两方面,要求膜层既有一定的硬度又有一定的厚度,并且能够实现快速镀制。目前通用的真空镀膜主要有真空蒸发、多弧离子镀和磁控溅射,真空蒸发由于附着力较差,用于耐腐蚀涂层存在着天生的不足。多弧离子镀镀膜具有离化率高、膜层和基体的结合力好、沉积速度快、绕射性好的优点,是一种较好的可选方法,但采用多弧离子镀制备的涂层颗粒大、表面粗糙度大、膜层致密性较差、这对于耐腐蚀涂层又是致命的缺点。磁控溅射沉积的膜层相比离子镀表面粗糙度小、膜层致密,但磁控溅射的离化率较低,一般只有3%,因此膜层结合力较差,沉积速度慢。对于耐腐蚀涂层的真空镀膜除了要求膜层结合力好,表面覆盖性好, 还要求涂层致密,沉积速度快。在真空镀膜的应用中一种折衷的方案是采用多弧离子镀先打底,制备一层薄膜涂层,然后再用磁控溅射制备一层薄膜,采用这种方案结合了两种方法的优点,但薄膜涂层的应力变化较大,制备厚的涂层有很大的困难。针对以上两方面的问题,我们这里提出了一种独特的方案,采用离子镀+ 磁控溅射弧光辉光协同共放电气相沉积(arc plating sputtering cement deposition,APSCD) 的方法制备混合薄膜。基于上述指导思想,提出具体设计方案,完成了一套弧光辉光协同共放电真空镀膜机的研制,并交付哈尔滨商业大学使用。
1、镀膜机的总体设计及改造
镀膜室采用立式前开门结构,内腔尺寸:800 mm(直径)×800 mm(长),外壁通冷却水。镀膜机采用分子泵抽气,减少了返油污染,结合力好,无斑点;安装了分别使用30 kW 中频溅射电源和3 kW 多弧电源的非平衡磁控溅射圆柱对靶和多弧圆柱靶;工件夹具采用往复式鼠笼式工件篮,无需挂具,装件量大,可镀制六面体结构的工件;偏压电源使用10 kW直流脉冲电源,可通过调节功率和占空比改变镀膜工艺,提高膜层的附着力;电控采用PLC+ 触摸屏控制系统,整个系统具有泵阀互锁、防爆、互保护功能可实现全自动真空镀膜。图1是镀膜机结构原理示意图。
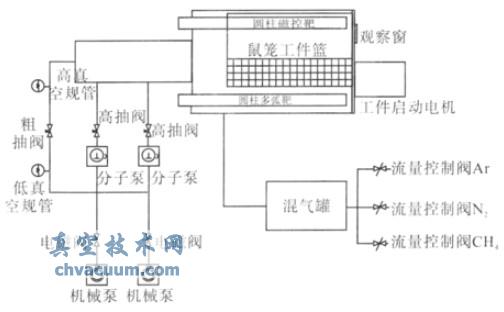
图1 镀膜机平面示意图
1.1、鼠笼式往复摆线工件篮的结构
真空镀膜在取代电镀时面临的最大挑战是膜层制备的绕射性。由于真空镀膜是在真空中完成薄膜的制备,膜层的沉积为平行于蒸发源,工件必须面对蒸发源,多采用挂件结构,垂直面的沉积速率即使在绕射性较好的磁控溅射也仅为平行于蒸发源的平面沉积速率的五分之一。此,真空镀膜多适用于平面较多的工件或圆形工件,不能用于结构复杂的工件,这些都大大限制了真空镀膜替代水电镀的应用,减慢了绿色环保的真空镀膜应用的步伐。对于紧固件这种六个面都需要镀膜的工件,通常使用的真空镀膜夹、卡、挂会使工件表面出现未镀膜的盲点,形成酸碱和水汽及氧分子的侵蚀点,形成的侵蚀点会加剧紧固件的腐蚀,因此无法采用真空镀膜常用的夹、卡、挂等方式固定工件。为了解决这一难题,本项目研究设计了独特的鼠笼式工件篮,把螺钉螺栓等紧固件装在工件篮内,篮内布有翻转挡板,当鼠笼工件篮摆线往复运动时,紧固件翻转,形成新的面对沉积源的面,多层不停的翻转,从而实现对紧固件每个面均匀镀膜。图2 和图3 分别是工件蓝和工件蓝摆线动作示意图。

图2 工件篮示意图

1.向左运动; 2.向右返回; 3.向右运动; 4.向左返回
图3 工件篮摆线动作示意图
1.2、圆柱靶的设计
本真空镀膜机在以前工作的基础上设计了新结构的圆柱阴极靶。多弧圆柱靶与磁控溅射靶材水平分置基材上下侧共同放电,基材表面在沉积了多弧离子镀大颗粒的同时也沉积了磁控溅射的小颗粒,一方面利用了多弧离子镀的高离化率及离子镀良好的基膜界面层结合力,另一方面利用了磁控溅射沉积薄膜的致密性,形成了一种混凝土式的共混结构,达到耐磨、耐腐蚀的目的。图4 所示的圆柱靶机构设计示意图,采用高磁场强度的钕铁硼磁铁,并用磁流体密封代替传统橡胶密封,从而克服转动部分漏水漏气的缺点。

图4 圆柱靶结构设计图
通常在磁控靶的设计中大多采用实物靶实验的方法改进磁控靶的性能,多次反复实验从而确定磁铁的磁感应强度和物理结构。随着计算机数值模拟技术的不断发展,特别是计算机模拟软件的应用和普及,目前越来越多的工程设计采用了预先的计算机数值模拟分析技术,然后根据数值模拟的结果进行工程设计,大大简化了设计的研制周期,降低了研发成本。本研究采用有限元分析软件ANSYS 模拟磁场的分布情况,确定了最佳的磁极分布、磁极尺寸和物理结构。目前国际市场的稀土材料大涨造成强磁的钕铁硼磁铁价格也随之大幅度增加,为了降低磁控阴极的生产成本我们又进行了铁氧体磁体的数值模拟,通过改变磁铁同靶材的距离增强靶表面磁感应强度。

图5 圆柱磁控靶磁场模拟数据
图5是有限元数值模拟圆柱磁控溅射靶磁感应强度的结果。磁铁尺寸为11mm×11mm×30 mm,磁铁磁感应强度1200 Gs,设计的靶表面最大垂直方向磁感应强度为240 Gs。图6 是有限元数值模拟圆柱多弧靶磁感应强度的结果,多弧靶的设计中由于要求的靶表面磁场强度不能太高,我们采用了单磁铁结构,设计的靶表面最大垂直方向磁感应强度为110 Gs,磁铁尺寸11mm×11mm×30 mm,磁铁磁感应强度1200 Gs。本研究中我们还对磁场数值模拟的结果同实际靶的磁场强度分布进行了比对研究。验证试验采用SHT- V 型特斯拉计测量了靶表面水平和垂直方向的磁感应强度,实验结果表面模拟磁感应强度同实际测量结果有较好的一致性,有关结果将另行成文进行描述。根据数值分析的结果设计的两种靶放电情况良好,靶材利用率可达85%。

图6 圆柱多弧靶磁场模拟数据
1.3、辉光弧光共放电的物理特性的研究
图7 是APSCD 辉光弧光协同共放电的结构原理示意图,多弧圆柱靶与磁控溅射靶分置基材上下侧协同共同放电,辉光弧光等离子体互相增强,基材表面在沉积了多弧离子镀大颗粒的同时也沉积了磁控溅射的小颗粒,形成了一种混凝土式的膜层同镀的共混结构膜层。磁控溅射利用的是气体放电中的异常辉光放电,利用磁场束缚电子,增大电子密度,提高等离子体的密度,其阴极位降很大,且位降区的宽度减小。磁控溅射中一般阴极电压为几百伏特, 电流密度<1 mA/cm2,多弧离子镀利用的是弧光放电,电弧放电产生强烈的辐射,放电区中温度最高点几千K,电弧放电其特点是电流密度极大而极间电压低,其自持依赖于新的电子发射机制,其电压一般仅为10 V- 20 V,电流则高达150 A。由于辉光弧光放电的机制不同,在辉光弧光共放电共沉积过程中要分析二者不同的等离子密度增强机制, 研究磁场对置结构下弧斑轨迹的运动的变化规律, 研究弧光放电高强度辐射造成的荷能电子碰撞电离增强特性。

图7 弧光辉光共放电沉积机构原理图
2、实验结果
2.1、表面形貌分析
图8 是采用磁控溅射,多弧离子镀和APSCD混合镀膜原子力显微镜的表面形貌图。图中可以明显看出:由于磁控溅射产生的颗粒直径本身较多弧离子镀小,所以表面更为平整,致密。而采用混合镀法,因为磁控溅射产生的小颗粒和多弧离子镀产生的大颗粒进行了混凝土式的混合,填补了大颗粒之间的空隙,得到的膜层较单独多弧离子镀更加平整致密。

(a)磁控溅射;(b)多弧离子镀;(c)混合镀
图8 三种工艺的表面形貌
2.2、膜厚的分析
实验中采用台阶仪对薄膜的厚度进行了测量,测量结果如下表3 所示。
表3 不同样品的薄膜厚度

在相同的时间内,磁控溅射仅为658 nm,APSCD 混合镀膜层厚度达到1345 nm,沉积速率提高了1 倍。磁控溅射采用了中频双靶结构,这已经较大的提高了磁控溅射沉积速率。在实际生产中,采用混合镀方式的膜层厚度更容易达到微米级,更适合用来进行工业生产。
2.3、耐腐蚀性能的分析
实验测定了腐蚀电位及腐蚀电流密度,采用电化学极化曲线对薄膜的耐腐蚀性能进行了评估。1#、2#、3# 试样和4#(基体)的极化曲线如图9 所示。基体的腐蚀电位是- 855 mV,1#、2#、3#号试样的腐蚀电位分别是- 776 mV、- 783 mV、- 751 mV。其中APSCD 混合镀膜试样腐蚀电位比基体的腐蚀电位提高了104 mV,耐腐蚀性能最好。

(1#)磁控溅射;(2#)多弧离子镀;(3#)混合镀; (4#)基体
图9 不同试样的极化曲线
3、结论
通过1 年的实验,设计的新型辉光弧光协同共放电镀膜机能够满足快速镀制耐磨耐蚀膜层的工业要求,靶材利用率高,系统协同放电稳定,该机能同时满足多弧和磁控镀膜的要求,提高了设备与薄膜制备的档次,并使所能镀制的薄膜范围大大增加。