TiO2/SiOxNy/SiO2层叠结构栅介质的电容-电压特性研究
本文讨论了以射频磁控溅射为主要工艺制备的TiO2/SiOxNy/SiO2 结构高k 栅介质。文中重点讨论了不同成分界面SiOxNy 薄膜作用下,栅介质整体电容- 电压特性的异同,并论述了SiO2 界面层在保证栅介质良好电学性能方面的作用。
为了应对SiO2 栅介质不断减薄所带来的漏电和能耗问题,从本世纪开始,寻找介电常数高于SiO2 的高k 栅介质材料成了半导体领域一大研究热点。但因为硅基底电学兼容性的限制,大部分已报道的高k 材料在综合电学性能方面都差强人意,部分已见应用的高k 材料多以高成本工艺条件为基础,或通过牺牲材料本身高介电常数优势的掺杂改性方法来实现。而像TiO2这类有较高介电常数,且工艺成本较低的材料也因为综合性能方面的不足无法得到推广。
本文以层叠结构栅介质为突破口,提出钛硅基栅介质研究,即利用沉积在TiO2 和硅衬底之间的SiO2 及SiOxNy (SION)层叠结构界面薄膜来改善TiO2 栅介质电学性能,具体结构可以表示为电极/TiO2/SiOxNy/SiO2/Si。文中以电容- 电压特性为分析重点,为推广TiO2 薄膜在MOS 栅介质领域的应用奠定基础。
1、实验
MOS 薄膜电容制备以电阻率为4 Ωcm~7Ωcm的p 型单晶Si(100)为基底,在自制实验平台上进行介质膜的溅射沉积和电极膜的蒸发沉积。本文所述电容包括以下五种结构:Al/TiO2/SiOxNy_1 (富氮)/SiO2/Si(结构A)、Al/TiO2/SiOxNy_2(富氧)/SiO2/Si(结构B)、Al/TiO2/Si(结构C)、Al/TiO2/SiO2/Si(结构D)、Al/TiO2/SiOxNy/Si(结构E)。结构A 和结构B 是本文的研究重点,即富氮SION 薄膜和富氧SION薄膜方案,用于探讨界面处不同SION 薄膜成分配比对电容整体性能的影响,后面三种结构则是在前期研究基础上给出的比较样本。结构C、D、E 的制备流程与前期研究[10]一致,界面薄膜以硅靶为源进行反应溅射,溅射功率均为500 W,反应气体流量分别是SiO2:QAr(氩气)为9.5 sccm,QO(氧气)为1.0 sccm;SiOxNy:QAr 为9.5 sccm,QO 为1.0 sccm,QN(氮气)为1.0 sccm。TiO2 采用射频溅射法沉积,所制得的TiO2 薄膜介电常数大致为50~70。
结构A 和结构B 是在保证SiO2 制备工艺不变的情况下,引入不同成分的SION 界面薄膜。具体实现时,将通过不同的溅射气体流量配比实现薄膜成分控制。SiOxNy(富氧)膜层将在氧气流量1.6 sccm、氮气流量1.0 sccm 的反应气体组合条件下通过反应溅射制得,综合前期工作结论和断面成分分析表明此条件下可将薄膜氧原子比例(O/(O+N))控制在0.85~0.95。SiOxNy(富氮)膜层将在氧气流量0.4 sccm、氮气流量1.0 sccm 的反应气体组合条件下通过反应溅射制得,此条件下可将薄膜氧原子比例控制在0.25~0.35。
为了降低工艺实施过程中外界杂质离子的影响,实验前对真空系统进行了改装使得各结构电容可以在保持真空状态不变的条件下通过原位换靶进行各层介质膜和电极膜的沉积,并在沉积后进行了N2 气氛退火以修复工艺缺陷。图1是TiO2/SiOxNy/SiO2 结构的典型TEM 断面结构图,显示了较清晰的分层效果。对栅介质的测试以高频电容- 电压特性测试(HP4294A 平台)为主,以分析其中的介质层界面特性。

图1 TiO2/SiOxNy/SiO2/Si 结构断面结构图
2、C-V 特性讨论
对MOS 栅介质电学性能的研究主要通过分析其电容- 电压(C- V) 特性入手。图2 是在1MHz 频率条件下对各结构电容进行测试得到的典型C- V 曲线图,所示电容值均以相应之积累态电容为基准作了归一化处理。由于电容基底为p型单晶硅,首先分析由栅介质电荷引起的负栅压方向C- V 曲线偏移。如图2 所示,C 结构电容的C- V 曲线偏移量最大,说明对应的栅介质电荷密度最大[5],结构A、B 和D、E 所对应的栅压漂移则比较相近。但同时反映出的趋势是层叠结构对应的偏移量小于单层界面介质对应的偏移量,而界面氮成分越高,其对应的偏移量也越小。说明了结合SION 界面薄膜的层叠结构在抑制栅压偏移方面的显著作用。
另一方面,对各结构电容所做的界面EPMA成分分析表明,结构C 中靠近硅衬底界面处的Ti成分最高,达到了5%,其次是以单纯SiO2 作界面的结构D,达到了2.1%,以SiOxNy 作界面层的结构E 中Ti 含量为1.1%,而结构A 的界面Ti 含量最少为1.0%,低于同样采用复合界面结构的结构B(界面Ti 含量:1.3%)和单层SION 界面的结构E。硅基底界面Ti 成分的出现主要源于工艺过程中TiO2 成分向硅衬底方向不同程度的扩散、反应。上述数据显示,扩散程度和SION 在界面所占比重是有直接关系的,在C- V 测试结果中,也直接表现为不同程度的栅压偏移量。
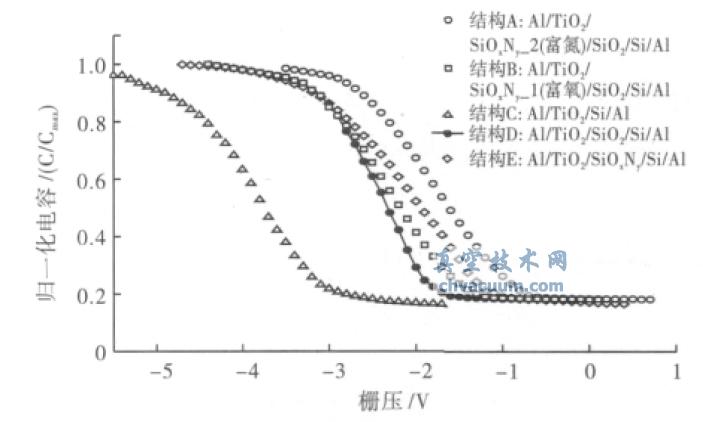
图2 各结构MOS 电容的电容- 电压(C- V)特性曲线
SION 膜层起到了抑制Ti 界面扩散的作用,而层叠结构中SION 膜层和SiO2 膜层在界面的层叠组合也在一定程度上降低了氮成分的界面态效应。作为反映界面电学质量的另一个指标,比较图2 中C- V 特性曲线的积累- 反型过渡区斜率可知,结构C 中C- V 曲线对应的过渡区较长,表现为较宽的电压轴方向延展和较低的斜率。结构A、B 和E 对应的过渡区在电压轴上的延展长度相近,相应斜率也均大于结构C,而A、B、E 三者中单纯SION 薄膜做界面的结构E 则显示了最低的过渡区斜率。上述结果表明,结合了SiO2 膜层后的层叠介质(结构A、B)有效抑制了SION 膜层中氮成分带来的界面态问题,界面质量得到明显改善。但结构A 和结构B 的斜率仍然低于单纯SiO2 作界面的结构D,由此可见,具有良好界面质量的SiO2 薄膜在层叠结构中是一个不可缺少的角色。
3、结论
本文通过对C- V 特性的深入分析论证了结合SiOxNy 薄膜的层叠结构在改善钛硅基MOS 栅介质综合性能方面的优势,以及一般工艺条件下,SiO2 膜层在改善高k 介质电学性能方面的重要作用,有助于进一步促进高k 介质的研究及应用。
全文下载:
TiO2/SiOxNy/SiO2层叠结构栅介质的电容-电压特性研究