硅衬底上无微裂稀反极性畴AlN 薄膜的分子束外延研究
硅衬底上无微裂稀反极性畴AlN 薄膜的分子束外延研究
胡健楠 钮浪 胡懿彬 鄂炎雄 郝智彪 汪莱 罗毅
清华信息科学与技术国家实验室(筹) 清华大学电子工程系 北京 100084
与蓝宝石和碳化硅衬底相比,硅(Si)衬底具有成本低、尺寸大等优势,在III 族氮化物半导体发光二极管市场中发展迅猛。Si 衬底上外延生长III 族氮化物技术中,氮化铝(AlN)薄膜作为改善异质外延界面、调控热失配应力最有效的过渡层,是最关键的外延层之一。然而,由于两者之间存在着晶格常数和晶体极性上的差异,AlN 外延层晶体质量的提高,受到了表面微裂和薄膜中反极性晶畴的困扰。针对此问题,本文发展了改进的迁移增强外延和单极性成核等技术。
结果表明,在分子束外延时,间断地通入N 源有助于消除表面微裂,得到了平坦的外延表面,1×1 mm2 均方根粗糙度仅为0.16 nm;同时,单极性成核处理可明显抑制反极性畴。由此获得了X 射线衍射半宽仅为0.27°的AlN 薄膜。
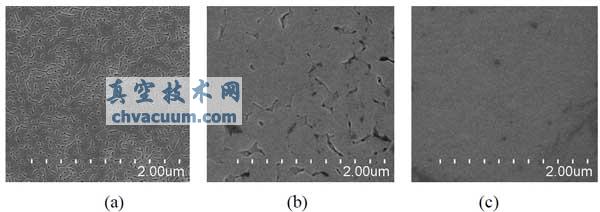
图1 采用传统方法(a)、交替通入Al 和N 源(b)和仅间断通入N 源(c)技术外延生长的AlN 表面扫描电子显微镜图像

图2 KOH 溶液腐蚀后的AlN 薄膜表面扫描电子显微镜图像对比(a) 传统生长工艺;(b) 采用单极性成核处理