一种崭新的镀膜技术――等离子体束溅射
蒸镀工艺的最大特点在于高的沉积速率, 缺点是薄膜的结合力低, 致密度差; 溅射工艺能制备致密高、结合力好的薄膜, 但存在成膜速度慢, 难以制备复杂膜、磁性薄膜等的缺点。本文将详细介绍一种崭新溅射镀膜技术以及应用此技术构建的系统。该种镀膜系统基于Plasma Quest公司创立的高利用率等离子体溅射源(H igh Target U tilization PlasmaSpu ttering (HiTUS) )。并介绍该系统在不同应用领域的使用结果。
1、高利用率等离子体溅射(H igh Target U tilization PlasmaSpu ttering (H iTUS) )源
H iTUS高利用率等离子体溅射源是一种崭新又古典的溅射源。他实际上是由利用射频功率产生的等离子体(ICP)源、等离子体聚束线圈、偏压电源等组成的一个溅射镀膜系统。该等离子体源装置真空室侧面。如图1 所示。图2为实际的镀膜机照片[a]。该等离子体束在电磁场的作用下被引导到靶上, 在靶表面形成高密度等离子体。同时靶连接有DC/RF偏压电源, 从而实现高效可控的等离子体溅射。等离子体发生装置与真空室的分离设计是实现溅射工艺参数宽范围可控的关键, 而这种广阔的可控性使得特定的应用能确定工艺参数最优化。
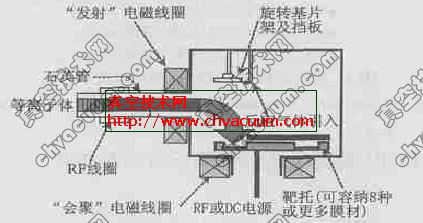
图1 高利用率等离子体溅射原理图
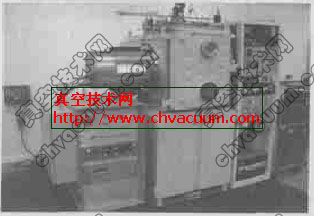
图2 HiTU S 技术的S400镀膜机
与通常的磁控溅射相比, 由于磁控靶磁场的存在而在靶材表面形成刻蚀环不同,HiTU S系统由于取消了靶材背面的磁铁, 从而能对靶材实现全面积均匀刻蚀。这种刻蚀方法的结果是靶材的利用率从一般磁控靶溅射刻蚀的25%提高到80%至90%。这就是这种系统取名“H iTU S”高利用率等离子体溅射(High Target Utilization PlasmaSpu ttering (HiTUS) )的原因。
2、HiTUS 镀膜系统组成
这种高效等离子体溅射镀膜关键部分是其高效的等离子体源。它的组成有独立供气系统的石英晶体腔体, 外部有耦合射频功率的感应线圈。感应线圈有冷却水冷却。射频电源采用频率为13. 56MHz 的激励频率。在压力为3×1023 hPa 时, 这种等离子体的离子密度为1013/cm3到1014/cm3。当放电管中的等离子体被引出时, 上述等离子体中的离子密度将降低为静止状态时的1/3。在放电管靠近真空室的一端, 有一个等离子体引出线圈, 此线圈产生的电磁场对等离子体进行集束控制。在真空室外侧与等离子体束轴线成直角的方向上装配有溅射等离子体束的汇聚线圈。溅射靶材处在此汇聚线圈以内的真空室内侧, 靶材通过电极与外界相连, 也可以设计成多种靶材的旋转靶结构。靶材做成电悬浮结构, 连接的加速偏压为直流0~-1000V。图3所示为不同材料在靶2源距离情况下, 沉积速率与靶表面功率密度的测试曲线。

图3 靶表面功率密度与沉积速率关系曲线
图4为靶电流与靶偏压的关系曲线。

图4 靶电流-靶偏压关系曲线













