栅极绝缘层和有源层沉积工艺的优化对TFT特性的影响研究
通过对低速沉积的栅极绝缘层(GL层)和低速沉积的有源层(AL层)的薄膜沉积条件进行了优化,分析了沉积AL层的功率,间距等条件的变更对薄膜的沉积速率和均匀性的影响,解释这些工艺条件对Ion的影响的本质,确定最佳的沉积AL层的沉积条件;调整了GL层的功率和NH3流量,分析了两者对Ion的影响规律并分析了内在的原因。通过对比优化前后的薄膜晶体管(TFT)特性曲线发现,Ion提升了32%,开关比(Ion/Ioff)提升了约40%,达到了优化TFT特性的目的。
目前,液晶显示器(LCD)正以其优异的显示品质及轻便性逐步取代普通的阴极射线管(CRT)显示器。对于大面积显示的LCD,采用有源矩阵是一种比较理想的选择,有源矩阵LCD采用的是薄膜晶体管(TFT)阵列,而TFT阵列主要使用a-Si:H作为TFT沟道。但是a-Si:H的载流子迁移率较低,其TFT特性尤其是开路状态下的电流较低,比多晶硅要小2~3个数量级,为满足充电要求,需要进一步提升a-Si:H的TFT特性。此外,由于氢化非晶硅(a-Si:H)薄膜存在比较大的缺陷密度,导致TFT中的a-Si:H薄膜和SiNx薄膜之间存在比较大界面态,使得a-Si:HTFT在光诱导或正栅极电压的作用下,会导致开路电流Ion的衰退和阀值电压的增大,对TFT的特性产生一定的影响,因而,在实际生产过程中,从提升产能和改善TFT特性的角度来考虑,一般将栅极绝缘层(GL层)和有源层(AL层)分为两步进行沉积,第一步为高速沉积层(GH层和AH层),所沉积厚度占整个厚度的绝大部分,此膜层结构较疏松,并且含有较多的缺陷;第二步为低速沉积层(GL层和AL层),这两层位于栅绝缘层和a-Si:H层的界面处,沉积速较低,膜层结构较致密,缺陷少。为了改善a-Si:H的TFT特性尤其是Ion的水平,本文对GL层和AL层的沉积条件进行了优化,最终达到Ion提升的要求。
1、实验
本文采用的玻璃基板尺寸规格为1100mm×1300mm。栅极绝缘层(SiNx)和氢化非晶硅层(a-Si:H)的沉积是在AKT-15K等离子体增强化学气相沉积(PECVD)系统中连续完成的。PECVD设备的具体参数为:本底真空优于1.33Pa,反应气体由SiH4,NH3,N2等气体组分生成,各气体的具体流量为SiH4的流量为1.69~3.38Pa·l/s,NH3的流量为6.76~10.14Pa·l/s,N2的流量为16.9~30.42Pa·l/s;氢化a-Si采用SiH4分解方式生成,其中SiH4流量为1.69~5.07Pa·l/s;H2流量为11.83~20.28Pa·l/s,SiNx沉积功率为3000~6000W,a-Si沉积功率为500~2300W,沉积温度为300~400℃,气压为133~333Pa。
图1为PECVD设备反应腔体截面图的示意图,在沉积的过程中,影响薄膜性质的因素主要包括下极板的温度、两极板之间的距离、功率和气体比率等相关因素。
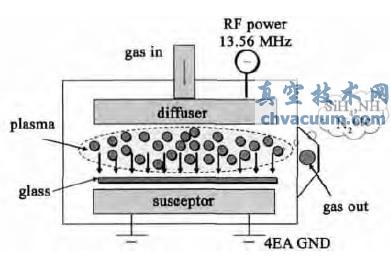
图1 PECVD设备反应腔体的截面示意图
反应气体通过由许多小孔组成的扩散口(diffuser)流入反应腔体中,此系统中沉积栅极绝缘层,通过一系列的化学反应生成栅极绝缘层(SiNx)和有源层(a-Si),所发生的主要反应如下

本文针对AL层的SiH4和H2流量、压力、间距以及功率设计了5因子2水平的1/4的部分因子实验,确定了AL层提升Ion的最佳的沉积条件,在AL层的最佳的沉积条件的基础上,设计GL层的NH3流量和功率的全因子实验。
3、结论
本文通过对AL层和GL层的沉积条件进行了优化,改善了薄膜的致密性和两层的界面态,分析了AL层的功率,间距的变更对薄膜的沉积速率和均匀性的影响,解释这些工艺条件对Ion的影响的本质;通过GL层的功率和NH3流量的全因子实验,揭示了富硅化的SiNx薄膜可以提高GL层和AL层的晶格匹配度,减少了界面态,有利于提升TFT的Ion,分析了功率对Ion的影响规律,通过对比优化前后的TFT特性曲线发现,条件的变更起到了优化TFT特性的目的。














