多层HfO2/Al2O3薄膜基电荷陷阱存储器件的存储特性研究
借助脉冲激光沉积和原子层沉积系统,采用SiO2作为隧穿氧化物,Al2O3作为阻挡氧化物,制备了多层HfO2/Al2O3薄膜基电荷陷阱存储器件。实验发现,当电极偏压为±12 V 时,存储窗口达到7.1 V,电荷存储密度约为2.5 × 1013cm-2。HfO2/Al2O3之间的界面在电荷存储过程中起着关键的作用,更多的电荷存储在界面的陷阱之上。经过3.6 × 104 s 的保持时间,25,85 和150℃测试温度下,器件的电荷损失量分别为5%,12%和23.5%。线性外推实验数据得到,150℃下,经过10 年的电荷损失量约为42%。器件优异的保持性能主要归因于HfO2/Al2O3薄膜之间较大的导带补偿。由此可以看出,多层HfO2/Al2O3薄膜基电荷陷阱存储器件是一种极具应用前景的电荷存储结构。
近年来,为了解决多晶硅浮栅存储器小型化过程中遇到的诸多问题,开发新型非挥发性电荷存储器成为微电子行业研究的热点。目前,SONOS(Polysilicon-Oxide-Nitride-Oxide-Silicon) 结构是应用最为广泛的电荷存储结构( 如图1(a) 所示) ,其中,顶层的SiO2主要用于防止Si3N4中电子的流失,称为阻挡氧化物;Si3N4主要用于俘获和存储电子,称为电荷陷阱存储层;底层SiO2为隧穿氧化物,该器件结构已经用于65 nm 以上节点的存储单元。但是,Si3N4的缺陷态具有复杂的陷阱能级分布,部分俘获的电荷被存储在浅能级缺陷态上,这些被浅能级束缚的电荷会由于Poole-Frankel 发射等原因而发生逃逸,导致存储信息被篡改,而且Si3N4与SiO2之间较小的导带补偿也不利于存储电荷的保持。
为了解决这一问题,国内外研究学者就器件的结构提出了一系列改进措施。美国Texas 大学的Kwong发现利用HfO2作为隧穿层,具有改善器件抗疲劳性能的特点。然而,相比传统的SiO2隧穿层,HfO2与Si 衬底之间的界面稳定性问题及隧穿层中较低的电场强度成为限制该存储结构发展的难题。韩国Kwangwoon 大学的You 等发现,HfO2作为存储层具有较大的导带补偿和电荷陷阱密度。但是,HfO2的结晶温度较低,晶化将导致较大的漏电流和严重的杂质扩散,从而影响存储器件的保持性能。
国外研究学者提出利用多元氧化物高介电常数(high-k) 材料作为存储层来提高电荷存储密度及器件存储特性。以上改进措施在一定程度上提高了电荷存储器件的存储性能,但是,仍有一些关键问题有待解决,例如,提高存储层陷阱密度的同时,如何确保器件具有良好的保持性能。本文利用多层HfO2/Al2O3薄膜作为存储层,借助脉冲激光和原子层沉积系统制备电荷陷阱存储器件,并对器件的存储特性进行了系统分析。
1、器件的制备与测试分析
1.1、 陶瓷靶材的制备
利用固态烧结方法分别制备HfO2和Al2O3陶瓷靶材( 靶材规格:厚5 mm × 直径20 mm) 。首先将高纯HfO2和Al2O3粉体置于行星球磨机( MSKSFM-1) 中充分研磨24 h;然后将研磨后的粉体放入烘箱( EQ-DHG-9140) 中烘干; 而后利用手动压片机(YLJ-15T) 将烘干后的粉体压制成型( 施加压强:15MPa) ;最终将预成型样品置于高温箱式炉(KSL-1500X-S) 中,在1400 ℃下烧制8 h。
1.2、电荷存储器件的制备
首先对硅衬底(p-Si) 进行标准的化学处理除去表面的杂质和氧化层,然后利用热氧化方法在p-Si表面氧化一层3 nm SiO2薄膜作为隧穿氧化物(TO) ; 脉冲激光沉积( PLD) 系统是制备纳米薄膜的主要方法,因此,利用PLD 在TO 上依次生长HfO2和Al2O3纳米薄膜作为存储层(CTL) ,HfO2和Al2O3的厚度均为2 nm( 激光发射源用KrF 准分子紫外脉冲激光器,频率范围为1 ~ 5 Hz,激光强度为1. 8 J /cm -2,沉积腔内的真空度为1 × 10-4Pa) ; 然后采用原子层沉积( ALD) 系统在CTL 上沉积10 nmAl2O3薄膜作为阻挡氧化物(BO) ,选用Al( CH3)3和臭氧作为金属铝和氧的沉积源。而后,将样品置于快速退火炉( RTP300) 中退火30 s( 炉内温度:900℃;退火气氛:N2) ; 最后,将退火后的样品置于磁控溅射腔体内,在BO 上生长一层200 nm 厚的金属铂( Pt) 作为上电极,制备的电荷陷阱存储结构如图1(b) 所示。
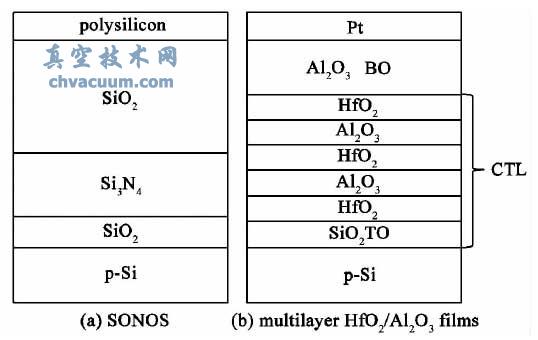
图1 电荷陷阱存储结构示意图
1.3、器件的微观结构表征和电学性能分析
实验过程中利用高分辨透射电子显微镜(HRTEM)观察器件的微观结构,采用X 射线光电子能谱(XPS) 分析器件的能带排列,通过4200 半导体参数测试仪(Keithley 4200 SCS) 测量器件的电容-电压(C-V) 特性和保持性能。
3、结论
借助PLD 和ALD 系统,制备了多层HfO2 /Al2O3薄膜基电荷陷阱存储器件,进而系统研究了器件的存储特性。实验发现,当电极偏压为±12 V时,电荷存储窗口达到7.1 V,电荷存储密度为2.5× 1013cm-2。这主要归因于器件的多层存储结构,更多的电荷存储在HfO2和Al2O3之间的界面陷阱上。
通过外推实验数据,25,85 和150℃ 测试温度下,器件经过10 年后的电荷损失量分别为18%,22%和42%。利用XPS 分析了器件的能带排列,由此得知,多层HfO2 /Al2O3薄膜基电荷存储器件中较大的CBO 是提高器件保持性能的主要原因。因此我们认为多层HfO2 /Al2O3薄膜基电荷存储器件是一种极具应用前景的电荷陷阱存储结构。