AlN纳米锥的图案化生长及场发射性能研究
以钼网作为掩膜,以镀Ni 的硅片为基底,通过AlCl3 和NH3 的反应,在700℃时实现AlN 纳米锥的图案化生长。图案化生长使AlN 纳米锥的屏蔽效应降低,场发射性质有明显改善。与未图案化的样品相比,图案化AlN 纳米锥的开启电压和阈值电压显著降低,场发射电流密度显著提高。这种图案化生长技术有望拓展到其它纳米冷阴极材料体系,优化其场发射性能。
1、引言
冷阴极场发射材料在军事及国民生活中都有广泛的潜在应用价值,近年来相关研究主要集中于冷阴极场发射材料在场发射平板显示器中的应用。冷阴极场发射材料的发展经历了三个时代。第一代为20 世纪60 年代后期出现的以Spindt 锥型材料(钼和硅的尖锥)为代表的冷阴极场发射材料,在锥状材料上施加电压后,其尖端会产生很强的电场,容易诱发电子发射。由于钼和硅具有大的表面功函,且Spindt 型钼/硅锥的合成路线复杂且造价昂贵,使这些材料很难付诸实际应用。随后,由于具有低(甚至负)的电子亲和势、高的化学稳定性和热传导性,金刚石/类金刚石薄膜材料成为第二代冷阴极场发射材料。然而由于薄膜的均匀度难以控制,且电子发射方向杂乱无章,使其不利于后续器件的组装,也逐渐淡出人们的视线。近年来以碳纳米管为代表的一维纳米材料的场发射性能研究引起了科学家的广泛兴趣,一维纳米材料具有大的长径比和纳米级尖端,可以有效提高材料的场增强因子,改善场发射性能。在选择合适的材料体系时,低的表面功函或电子亲和势、高稳定性及优异热传导性是重要的参考指标。
AlN具有低(甚至负)的电子亲和势、高的稳定性及优良的热导性能,其一维纳米材料可望成为一种有潜力的纳米冷阴极材料。近年来各种形貌的AlN 一维纳米材料,包括纳米管、纳米线、纳米带、纳米锥等,已被相继合成。在这些纳米材料中,AlN纳米锥阵列具有锐利的尖端,大的长径比及较好的定向性,也表现出较好的场发射性能。为了进一步优化AlN 纳米锥的场发射性能,有两种途径值得尝试: 一种是通过掺杂其它元素(例如:硅)以提高载流子浓度;另一种是通过降低纳米锥的密度以降低屏蔽效应。Nilsson等人通过实验和理论的计算得出:场发射头的密度增加时,屏蔽效应增强,场增强因子及发射电流降低,当两个一维纳米发射头之间的距离是其高度的2倍时,单位面积的场发射电流最大。因此,AlN 纳米锥的密度对其场发射性能有重要的影响。正如真空技术网的其它文章中报道,当AlN 纳米锥的密度较大时,由于屏蔽效应,场增强因子及发射电流会降低。
图案化生长是一种很好的控制纳米结构密度的方法,主要有两种途径: 一种是通过电子束刻蚀、紫外光照射等技术选择性地修饰基底的亲疏水性,构建图案化的基底;另一种方法是通过构建图案化的催化剂进而影响纳米结构的图案化生长,由于AlN 纳米锥的生长不需借助催化剂,且对基底材料没有要求,因此上述途径无法诱导AlN 纳米锥的图案化生长。本文通过引入钼网作为掩膜实现了AlN 纳米锥的图案化生长。与未图案化的产品相比,图案化的AlN 纳米锥具有更好的场发射性质,有利于其在场发射平板显示器中的应用。
2、实验部分
AlN 纳米锥的图案化生长是通过引入钼网作为掩膜以AlCl3 和NH3 在700℃下反应实现的(如图1A 所示)。将钼网紧紧附着的硅片放置于管式炉的中心,当沉积区温度升至700℃时,三氯化铝在氩气气流的带动下到反应区域,并与氨气反应,AlN 纳米锥在钼网的间隔沉积,而被钼网覆盖的地方则没有AlN 的沉积。反应持续4 个小时,在氩气气流的保护下冷却至室温,反应结束后,将钼网除去得到图案化的AlN 纳米锥。本文中尝试了两种不同尺寸的钼网作为掩膜。同时在相同条件下制备了未图案化的AlN 纳米锥作为比较。
样品通过X射线衍射仪(XRD; Philips X’pert Pro X-ray diffractometer)及扫描电镜(SEM;Hitachi S-4800)进行表征。场发射性质的测量在1 ×10-4 Pa的真空腔中进行。
3、结果与讨论
两种不同尺寸的图案化AlN 纳米锥SEM 照片如图1B-F 所示。对于图案化样品I,沉积区的尺寸为185 μm,两相邻沉积区的距离为35 μm,与所用钼网的尺寸相一致。在沉积区单元的AlN 纳米锥呈准定向分(图1D)布,而被钼网覆盖的地方则没有AlN 的沉积(图1E)。对于图案化样品II,沉积单元的尺寸为100 μm,而两相邻沉积区的距离较大,为60 μm(图1F)。图案化样品比较均一,有利于其在平板显示器上图案化像素的应用。未图案化的AlN 纳米锥的SEM 照片如图2 所示,纳米锥呈准定向排列,且尺寸均一,与图案化样品相似,说明有无钼网对于AlN 纳米锥的形貌没有影响。
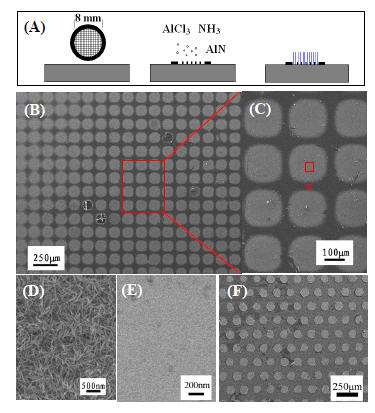
图1.(A)图案化生长过程示意图;(B)图案化样品I 的SEM 照片;(C)图B 中红色方框中放大的SEM 照片;(D)图案化样品I 沉积单元的SEM 照片;(E)图案化样品I 被钼网覆盖区域的SEM 照片;(F)图案化样品II 的SEM 照片。
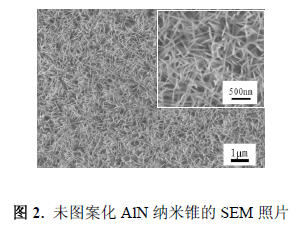
与未图案化的AlN 纳米锥相比,图案化AlN 纳米锥具有更大的边缘区域。由于边缘区域的屏蔽效应较低,图案化AlN 纳米锥应该会具有较好的场发射性质。图3 给出了图案化样品及未图案化样品的场发射曲线。样品的开启电压(Eto, 产生10μA/cm2 电流所需要的电场)和阈值电压(Ethr, 产生1mA/cm2 电流所需要的电场)如表1 所示。结果表明,图案化AlN 纳米锥样品的开启电压及阈值电压有显著降低;与图案化样品I 相比,图案化样品II 具有更小的开启电压和阈值电场。图案化AlN 纳米锥具有较大的边缘区域,且样品II具有相对更大的边缘区域面积;由于这些边缘区域的AlN 纳米锥的密度减小,使得屏蔽效应降低,从而导致了其场发射性能的增强。尽管图案化AlN 纳米锥的阈值电压高于碳纳米管,但是可以和氧化锌及硼纳米线相比拟。结果表明,图案化生长是一种有效且重复性较好的提高AlN 纳米锥场发射性质的方法。
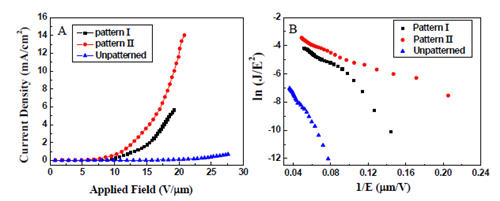
图3.(A)图案化样品I、II 及未图案化AlN 纳米锥阵列的电流密度~电场曲线(J-E 曲线);(B)与J-E 曲线相对应的Fowler-Nordheim 曲线,即ln(J/E2)-1/E 曲线。
表 1. 图案化及未图案化样品的Eto, Ethr 及 β 值

F-N 曲线如图3B 所示。根据F-N 理论,F-N 曲线的斜率等于-6830φ3/2/β,其中φ为功函,β 为场增强因子。AlN 的功函以3.7eV 计算[6],未图案化AlN 纳米锥的场增强因子为430。
由于屏蔽效应的降低,两个图案化样品的场增强因子有了明显的提高(表一)。对于图案化样品I,其F-N 曲线分为两段,在高场和低场的场增强因子分别为950 和600,这可能是由于空间荷电效应引起的。从图3A 可看出,在高场部分,图案化样品I 的电流至少是未图案化样品的5 倍。高的电流密度会通过电离残余的气体分子产生空间电荷,在电场作用下,正离子移动到AlN 发射头的尖端,使得发射头的电压增加,因此在高电场时具有较大的场增强因子。而图案化样品II 在低电场时就具有大的电流密度,荷电效应在整个电场下都存在,因此其F-N 曲线呈线性,场增强因子为1561。
4、结论
本文通过引入钼网作为掩膜发展了一条简单的制备图案化AlN 纳米锥的方法。图案化AlN 纳米锥具有均一的形貌及准定向的排列。由于增加了边缘区域,图案化生长有效降低了屏蔽效应,使图案化AlN 纳米锥的开启和阈值电压有了明显的降低。结果表明图案化生长是一种有效提高AlN 纳米锥场发射性质的方法,也有望进一步应用于优化其它纳米冷阴极材料的场发射性能。













