p-ZnO薄膜的掺杂研究现状
I族元素掺杂
在I族掺杂元素中,人们已经对Li、K、Ag、Cu、Au进行了一定研究。Au由于有+1、+3两个价态,在ZnO中既可作为受主,又可作为施主,情况较为复杂,并且实验没有测出其能级位置。Ag、Cu作为受主存在,受主能级很深,分别在导带底0.23eV和0.17eV处(如图1所示)。Wan Q X等利用第一原理对Ag掺杂的ZnO的晶体和电子结构进行了计算,结果表明Ag优选取代Zn位,AgZn表现为深受主行为,因此在Ag 掺杂的ZnO中难以得到p型ZnO,也就是说单纯掺杂Ag难以得到p-ZnO。在掺Li的ZnO薄膜中,Li原子置换Zn原子,作为受主存在,但Li原子由于尺寸较小,会有一部分成为间隙原子,此时Li不再是受主,而会引起深能级空穴陷阱,作为施主存在,因而,虽然Li总体表现为受主,但因高度的自补偿作用,没有测出其能级位置。总之,在ZnO中,I族掺杂元素能级很深,掺杂浓度也不高,因此作为受主掺杂并不是十分理想。表1 是I 族元素掺杂的p-ZnO薄膜的一些研究结果。
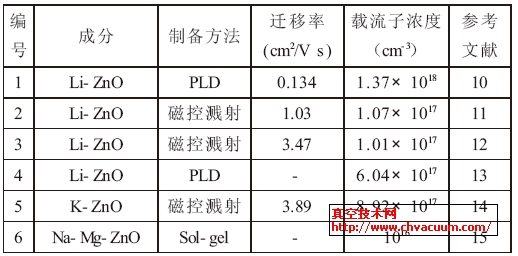
表1 I族元素掺杂的p-ZnO薄膜的研究结果
V 族元素掺杂
N掺杂
Kobayashi A在1983年就预言在ZnO薄膜中,N是非常好的浅受主能级掺杂元素。最初Sato Y等尝试使用O2和N2混合气体来制备N掺杂的ZnO薄膜,但是没有得到p 型薄膜。直到1997年,Minegshi K等得到掺N的p型ZnO薄膜,掀起了N掺杂p-ZnO的研究热潮。在N掺杂的p-ZnO薄膜研究中,N掺杂源多选用N2O和NH3,而N2和NO选用较少。N2只有在活化后才能实施活性N的掺杂而作为有效受主,Chakrabarti S等利用PLD的方法,以电子回旋共振(ECR)活化N2作为N源制备出了p-ZnO薄膜,在较宽的温度范围内薄膜为p型,但是其室温空穴浓度仅为5×1015cm- 3。Lu Y F等以NO 为N 源,用等离子体辅助的MOCVD方法,研究了不同RF 功率对ZnO 薄膜性能的影响。在功率为50W时得到的为n-ZnO,在100和120W时为混合型,而当功率为150W或更高时,得到p-ZnO。其原因可能是在功率较低时,N处于间隙位置导致n 型导电,而功率升高时会促使N 原子处于取代位置成为受主。
N2O 是制备p- ZnO 的理想气氛,经ECR 活化后,会产生活性分子(原子),对p- ZnO 的生成起到关键性的作用。Joseph M等使用N2O 气作为N 源,以ECR 活化制备出了p- ZnO 薄膜,并利用Ga- N 共掺,得到了低阻和高载流子浓度5×1019 cm- 3 的p- ZnO 薄膜。
NH3 作为有效的N 源进行掺杂时,由于H的钝化作用可增加N 掺杂浓度,N 和H 会以1:1结合成牢固的N- H键进入ZnO 中,以受主形式存在,从而增加N 的掺杂浓度。
叶志镇等用直流磁控溅射的方法在α- Al2O3(0001)衬底上以NH3- O2 为工作气体制备出了N 掺杂的ZnO 薄膜,在氨分压50%衬底温度500℃时得到p 型薄膜。Zhang Y Z 等对使用NH3 以磁控溅射得到N 掺杂的ZnO 进行了后期退火处理的详细研究,未退火前由于H 的钝化作用,薄膜具有较高的电阻率,达103 Ωcm,而在N2 氛围下500℃退火10min 后, 得到p 型薄膜,其电阻率下降为7.73 Ωcm,载流子浓度为9.36×1017 cm- 3,迁移率为0.86 cm2/Vs。利用光吸收谱对p- ZnO 薄膜中的H 和N 进行了分析,发现在薄膜中存在大量的No- H 对,经过退火处理后No- H 对分解而导致活性的N 受主存在,因而能得到p 型薄膜。Lee C M 等以NH3 为N 源利用原子层外延(ALE) 的方法在蓝宝石衬底上也成功地生长出N 掺杂的p- ZnO 薄膜。
在制备N 掺杂的p- ZnO 薄膜中,KaminskaE 等另辟蹊径,利用磁控溅射方法以Zn 为靶材,在Ar+N2 氛围下首先制备出Zn3N2 薄膜,然后在O2 氛围下退火氧化得到N 掺杂的p- ZnO 薄膜。在N2 分压为90%并经600℃退火15 min 后薄膜的性能最佳,载流子浓度1017 cm- 3,迁移率数量级为102 cm2/Vs。利用此方法的还有Kambilafka V、Wang C和张军等。
超声喷雾热分解的方法也被用来制备N 掺杂的p- ZnO 薄膜。Ji Z G 等用此方法以乙酸锌和氨水的混和溶液制备出了掺N 的p 型ZnO 薄膜,Zhao J L 等制备出的p 型ZnO 薄膜的载流子浓度约为1018 cm- 3,迁移率约为102 cm2/Vs,电阻率低至10- 2 Ωcm。
P掺杂
人们在开展N 掺杂的同时,也开始了其他V族元素的掺杂研究,如P、As 和Sb。Jiang J和MiaoY 等利用MOCVD 的方法,以P2O5 为P 的掺杂源,制备出了P 掺杂的p-ZnO 薄膜,其导电类型强烈依赖于衬底温度,在360℃~420℃范围内得到p 型,超过此温度又变为n 型,并且温度较低时薄膜的电阻较高。当衬底温度高于420℃时,一些本征缺陷如空位氧和间隙锌的浓度要高于活性受主,因此出现n 型。
Doggett B 等以PLD方法制备出的P 掺杂ZnO 薄膜, 在黑暗环境中样品显示n 型导电,经过白炽灯照射后,样品由n 型变为p 型。利用磁控溅射方法制备P 掺杂的p- ZnO 薄膜有Ding R Q、Bang K H和Ahn C H等。
Ding R Q 等在P 重掺杂的Si 衬底上制备出ZnO 薄膜,然后通过退火处理使P 从衬底扩散到薄膜中实现n 型到p 型的转变。Bang K H 等在InP 衬底上制备出ZnO 薄膜,然后以Zn3P2 为掺杂源进行掺杂,掺杂后可以观测到薄膜由n型转变为p 型。
As 掺杂
Ryu Y R 等首次用PLD 方法将半绝缘的(001)- GaAs 衬底中的As 原子热扩散到ZnO 薄膜中而实现了其p 型转变,当衬底温度在400~500℃时可直接获得p- ZnO 薄膜,而当衬底温度在300~400℃范围内只能生成n- ZnO 薄膜,随后对样品在500℃ 下作退火处理均得到了p- ZnO 薄膜,受主掺杂浓度为1018~1021 cm- 3,迁移率0.1~50 cm2/Vs。但是这个结果也存在争议,因为Zn 也可能会扩散到GaAs 中形成p 型GaAs:Zn 薄膜,实验测得的p 型导电性有可能来自于掺Zn 的GaAs。
Shen Y Q 等使用掺As2O3 的ZnO 靶利用PLD 的方法制备出的As 掺杂p- ZnO 薄膜,其空穴载流子浓度为1016 cm- 3,电阻率为3.35 Ωcm,迁移率为26.41 cm2/Vs。研究表明,与As 有关的缺陷中,As 应该以AsZn 而不是以AsO 形式存在,As 原子占据Zn 位并导致两个Zn 空位出现,即AsZn- 2VZn,其具有低的形成能并形成浅的受主能级。Fan J C 等[43~45]以ZnO 和Zn3As2 为靶材用共溅













