钨涂层面对等离子体材料出气性能的研究
钨由于高熔点、低溅射率等优点而被广泛的认为是最有希望的核聚变装置面对等离子体材料。然而考虑到等离子体约束和边界气体再循环,钨涂层面对等离子体材料在真空中的出气性能的研究是十分重要的。研究结果显示钨涂层主要出气种类为H2,H2O,O2,CO/N2和CO2。在300℃、经过4小时的烘烤,涂层出气率有明显的降低,特别是H2O 和CO/N2;继续烘烤对涂层出气率改善效果不显著,因此真空等离子体喷涂钨涂层在用作面对等离子体材料时,仍需要烘烤、放电清洗等壁处理手段。
等离子体喷涂技术虽然解决了钨铜两者由于膨胀系数和杨氏模量的巨大差异所引起的连接困难,但是等离子体喷涂钨涂层(PS-W)多孔性的特点使其作为核聚变面对等离子体材料(PFM)成为一个问题:气孔不仅降低了涂层间粒子的结合强度、影响整体部件的传热能力,而且使得核聚变燃料气体的滞留量以及再循环行为增大。因此钨涂层在承受高热负荷过程中的出气特性如何直接关系到该种材料的真空性能,所以钨涂层在高热负荷条件下的出气研究是非常重要的,但是国内外文献对钨涂层面对等离子体材料的真空性能的报道却很少,特别是针对纯钨涂层的研究。为了消除基体材料对出气性能的影响,作者把真空等离子体喷涂钨涂层从铜合金基材上剥离并对其进行了真空特性的研究。
1、实验设置
3 块钨涂层大小均为30×30×1 mm3,实验前对样品的处理分别是:第一块样品只进行超声波清洗;第二块样品超声波清洗后,在300℃温度下烘烤4h;最后的样品则首先超声波清洗,然后在300℃烘烤7h。
采用电子束热负荷实验平台对其进行出气分析。实验过程中温度变化通过热电偶测量,测量范围从室温到1000℃,出气种类和出气量通过四极质谱仪(QMS)检测。
2、钨涂层出气性能
图1 是抽真空后本底真空情况。从图中可以发现:本底主要气体成份为水蒸气(H2O),扣除本底气体即检测量减去本底量质谱图如图1(b)所示,H2O 出现了负值,这主要是由于质谱检测到的H2O 量远低于本底,所以出现了负值,其他气体含量基本达到可以忽略的水平,因此通过对本底真空的分析可以判断:通过扣除本底气体等方法可以消除实验装置对钨涂层真空性能所带来的影响。图2为真空等离子体喷涂钨涂层的真空出气性能。
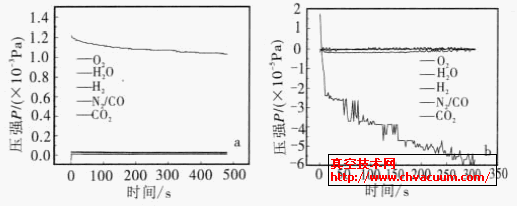
(a) 本底质谱曲线(b) 扣除本底后质谱曲线
图1 实验装置本底真空情况

(a)W 涂层原样质谱曲线,(b)300℃、烘烤4 h 后W 涂层质谱曲线,(c)300℃、烘烤7h 后W 涂层质谱曲线
图2 VPS-W 涂层真空出气性能
W 涂层样品主要出气气体为H2、H2O、O2、CO/N2、CO2, 特别是H2。在整个升温区间(20~1000℃),H2 表现出最大的出气量,然后是H2O,由于真空制备环境和空气中氧含量较少,所以涂层对O2 和CO2 吸附量也较小,故整个解吸实验中表现出较小的出气率。从峰值出现的温度范围可以看出,H2 主要出气峰值在400~500℃,而CO/N2 的峰值在1000℃,其他气体的出气率随着温度的增加而增大,没明显峰值,这些结果与Hirohata 等人研究结果相一致。在300℃、经过4 h烘烤后,涂层出气率有明显的降低,特别是H2O 和CO/N2,然而,H2 在400~500℃仍然出现了较高的出气峰值。进一步分析发现,延长烘烤时间(7 h)水的出气率有所降低,但是对其他气体出气率的影响不是很明显,这可能与气体在涂层中的吸附机理有关。
3、钨涂层出气性能讨论
对于物理吸附(0.3eV 结合能),可以通过真空烘烤让其解吸,但对于化学吸附(3 eV 结合能)的原子或分子只有从外部入射粒子中得到较大能量时才能释放出来。由于入射粒子的解析机制是动量转换,入射电子或光子引起的解吸率要比入射粒子引起的解吸率低2~3 个数量级。一般而言,在等离子体放电过程中要周期性的进行壁处理,壁处理的方法有:烘烤,主要是去除装置内壁的水分;放电清洗(辉光放电、泰勒放电清洗与射频放电清洗),主要去除装置内壁的碳、氧等轻杂质;镀膜技术(硼膜、碳膜、锂膜、硅膜等),控制氧杂质和工作气体的再循环。同样,对于钨涂层面对等离子体材料,烘烤仍然是壁处理的第一步。通过前面的研究判断:在300℃,经过4 h 的烘烤能有效的去除涂层内的吸附气体。然而,针对碳氧以及氢气体,单纯的烘烤效果不是太明显,同时在放电过程中,不断有气体吸附到涂层表面,所以VPS-W 涂层周期性的进行放电清洗等处理手段也是必需的。虽然,从壁处理过程工艺考虑,钨涂层比石墨PFM没有表现出优越性,但是氢及其同位素或其他杂质在钨涂层材料中的滞留量很小,所以钨涂层面对等离子体材料壁处理工作(壁处理时间和工作量)相比石墨面对等离子体材料而言要简单很多。
4、结束语
面对等离子体材料的真空性能直接关系到核聚变等离子体约束和边缘等离子体气体再循环。钨涂层出气种类主要有H2、H2O、CO/N2、O2 和CO2。在300℃、经过4h烘烤后涂层出气率有显著降低,特别是H2O 和CO/N2,然而H2 在400- 500℃仍然有较高的出气峰,且继续烘烤效果不明显。钨涂层在用作核聚变面对等离子体材料时,真空烘烤、放电清洗等壁处理手段仍是必要的。