一种崭新的镀膜技术――等离子体束溅射(2)
可以看出, 改变等离子体源的激励功率可以改变靶电流, 即改变靶功率, 从而改变沉积速率。在等离子体源激励功率保持不变时,通过改变靶偏压(尽管在偏压超过100V后出现了靶电流出现了饱和),也可以改变靶功率,从而改变沉积速率。正是这种靶电流的饱和现象为不同的镀膜工艺提供了更广泛的选择空间。例如, 在半导体镀膜中,二次电子的轰击容易引起器件损坏。在HiTU S系统上,可以降低靶偏压, 减小二次电子的轰击。但同时,通过提高等离子体源的激励功率, 同样可以保持不变的靶功率, 即保持不变的沉积速率。
在另外的应用中, 可能还有正相反的要求, 要求基片在成膜的同时利用二次电子的反溅射效用。此时可以减小等离子体激励功率, 减小靶电流, 同时提高靶偏压, 保持恒定沉积速率, 但增强二次电子对基片的轰击效用, 达到反溅射的目的。
3、几种典型的应用举例
光学薄膜的制备: 目前, HITU S技术的镀膜机被利用在光学薄膜制备的各种工艺。从高效率(1nm/s)、低成本的($1/W ) 的多晶硅太阳能电池板镀膜, 到多层工艺的光学滤波器镀膜。
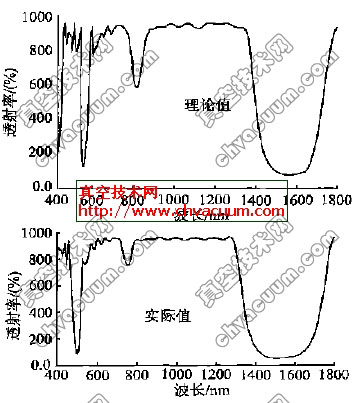
图5 实际与理论值对比曲线
多成分合金的共溅工艺: 多种成分的合金薄膜目前没有理想的制备方法。电子束蒸发是目前常用的手段, 但此工艺存在的缺点很多, 包括重复性差、薄膜微结构不理想等。利用HITU S系统, 可以非常容易地制备多成分合金膜, 不管这种合金是金属-非金属系, 金属-金属系, 还是其中包括有磁性材料的膜系。

图6 共溅
反应溅射工艺: 利用反应气体直接生成等离子体, 可以更有效的提高反应溅射的成膜质量, 这是离子辅助或磁控溅射很难做到的。HiTU S系统甚至可以用高氧化性的气体如O2, Cl等作为工艺气体, 而不会对系统或等离子体源产生影响。
极低溅射速率的镀膜: HiTU S系统有非常宽的调节特性, 溅射速率从几nm/s 到一般的几百A/min。但有些场合, 要求稳定的溅射速率越低越好。HiTU S 系统也同样可以满足这种要求。图7 为溅射速率与偏压的调节曲线。可以看出, 在几十A/min的溅射速率时, 同样有很稳定的放电。

图7 低速溅射的控制
4、结论
本文详细介绍了一种崭新的等离子体溅射技术以及由此技术组成的系统(HiTUS系统)。该系统可广泛地应用在光学、磁学等复杂的薄膜制备工艺中。由于具有非常宽的调节特性, 该系统对各种工艺的适应性非常好。同时, 由于不使用磁铁, 这种镀膜方法非常适合镀制磁性薄膜, 并且进一步的研究显示,通过调整镀膜工艺, 这种工艺手段可以控制成膜的晶粒度大小。













