等离子体发射监控系统参与的中频孪生反应磁控溅射沉积TiO2薄膜的实验研究(2)
图中还可以看出系统总压强的迟滞走势与沉积速率的变化是同步的,从中也不难推测出在金属态与中毒态各自对反应气体的消耗情况:O2 流量增加过程中,初始阶段增加的O2 流量被靶面完全消耗,真空度几乎不变,全面中毒时O2 的消耗减少,系统总压强才突然升高, 上升拐点出现在O2 流量=75sccm处;而O2 流量反向调节的减小过程中,初始阶段的中毒靶面几乎不消耗O2 (因为此时溅射的就是TiO2 靶面而非金属Ti 靶面) ,所以总压强并不立即同步下降,待中毒态完全消失时O2 被完全消耗,系统总压强才又突然降低,下降拐点出现在O2 流量= 24sccm 处。
图3 本实验所得反应溅射TiO2 薄膜的真实迟滞曲线(Ar 流量固定为90sccm) 图4 TiO2 的沉积速率随PEM设定值的变化关系
需要指出的是,不同的装置所得的迟滞曲线的具体数据可能不完全一样,但趋势应该是完全相同的,所以图3 很好地定量地说明了具体反应溅射的迟滞现象(反之图1 只能定性说明) 。
2.2、反应溅射TiO2薄膜的沉积速率随PEM设定值的变化关系
迟滞效应缘于传统的气体(特别是反应气体) 供应手段无法及时快速地响应过渡态所需的精准反应气体流量,以至于反应气体要么过量,要么不够,而对应的沉积速率要么是比较高的金属(这是不允许的) ,要么就是很低的中毒态,中间没有可以稳定维持的过渡态。而PEM 系统就是专为解决这个难题而研发的。图4 给出了本实验中得到的有PEM 参与时反应溅射TiO2 沉积速率与PEM 设定值之间的关系(电源设置为恒流65A) ,注意本图中横坐标不再是反应气体的流量而是PEM 设定值,此时O2 流量无法真实显示。设定值(Setpoint ,简称SP) 是指PEM设定的反应溅射时的等离子体光强相对于相同溅射功率下金属溅射时的相对强度,它决定着反应溅射的沉积速率(实际上间接控制氧气的流量,只不过是快速动态调节) ,考虑到测量误差方面的因素,可以看出本实验中TiO2 的沉积速率与PEM设定值呈很好的线性关系。
有了PEM的参与,反应溅射的沉积速率至少可以提高2 倍以上,并可原则上稳定在速率曲线上的任意值(当然还是有一定范围的,下节将对此专门论述) 。不但可以完全避免中毒态,工艺控制过程也极为方便。这是传统的反应溅射装置所望尘莫及的。设定值是PEM控制系统最关键的参数,它直接决定着控制的可靠性与所沉积薄膜的微观结构。PEM控制系统对溅射电源和Ar 气流量的稳定性要求很高,因为这会影响等离子体本底值的准确性。另外,如果工作中真空室出现超过一定量的杂质气体(比如基材的放气) ,将会干扰PEM 的控制,使反应气体的送入量产生非正常振荡,镀出的薄膜质量可能不合要求。
2.3、PEM 设定值对TiO2 薄膜的透射率及微观结构等方面的影响
图4 的结论似乎是有了PEM 的参与,TiO2 的沉积速率可以设定在曲线上的任意值。实际上一般不能这样做,因为PEM的设定值不但直接决定沉积速率,它还影响TiO2 的微观结构或化学配比,也就是说,如果设定值不合适,镀出的很可能不是纯净的TiO2 甚至根本就不再是TiO2 了。图5 给出的是本实验在载玻片上沉积的TiO2 的全光谱透射率与PEM设定值之间的关系(溅射电流65A ,全部样品的TiO2 涂层厚度相近,均约100nm) 。很明显,在设定值为118~318 之间的所有TiO2 样品,其全光谱透射曲线几乎重合,说明这些TiO2 薄膜的微观结构是相同的;但设定值一旦超过3.8 ,从SP = 3.9 开始,透射曲线明显偏离,说明这时TiO2 薄膜的微观结构开始变异。对这些样品的XPS 分析测试表明SP = 1.8~3.8 之间的反应物均为标准化学配比的TiO2 ,SP >3.8 时反应物的化学结构除了TiO2 外还含有TiOx ,其中x < 1 ,已经不再是标准化学配比的;SP 越大,涂层中Ti 的含量越大(实际上,就PEM 的工作原理而言,SP 就表示反应程度,当其大到一定值时,表示靶面进行的是纯的金属溅射而没有反应的发生) ,透射曲线整体性地下降得越厉害,说明在本实验条件和工作参数下虽然TiO2 的沉积速率与PEM 设定值有近似正比例的关系,但是SP 超过一定值,TiO2 的结构与光学性能开始出现突变。这表明,为了得到标准化学配比的反应物, PEM 的设定值有严格的范围,并不是任意的,必须对设定值对应的样品进行分析测试。提高沉积速率固然重要,但化学配比也就是反应物的成分或结构更为重要(PEM 的参与并不明显影响TiO2 的晶体结构,其主要决定于基片的温度以及溅射功率。) 。
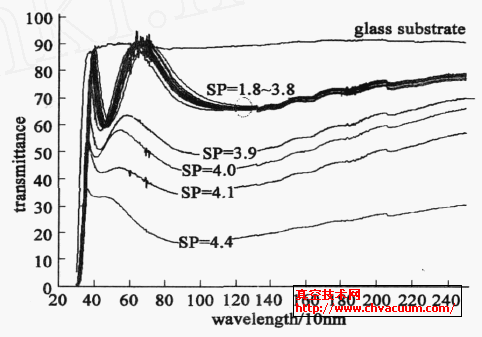
图5 载玻片上沉积的TiO2 的全光谱透射率与PEM设定值之间的关系
3、结论
反应溅射沉积TiO2 薄膜的迟滞现象不但见于直流单靶,也可能出现在配以中频电源的孪生靶。采用晶体振荡仪进行沉积速率的在线监测可以准确快速得到沉积速率的真实迟滞曲线,系统总压强的迟滞走势与沉积速率的变化是同步的。
PEM系统可以彻底消除反应溅射中的迟滞现象,沉积速率与PEM 设定值有很好的线性关系,薄膜的沉积速率原则上可以稳定在任意大小值,在同一溅射进程中沉积速率直接由设定值决定,工艺控制过程极为方便,适合于工业化生产。与没有PEM相比,相同溅射条件下的沉积速率可以提高两倍以上。虽然如此,为了得到标准化学配比的薄膜,PEM的设定值有严格的范围,不是任意的。确保化学配比也就是薄膜的成分或微观结构比提高沉积速率更为重要。















